SOLIDWORKS热应力分析:从基础入门到进阶完整实操教程
日期:2026-04-07 发布者: Enrique Garcia 浏览次数:次
当产品承受热载荷时,会产生热应力,为了保证产品的功能实现和使用安全,我们必须对这类应力进行分析。SOLIDWORKS Simulation 仿真套件针对不同的热工况,推出了多款定价不同的有限元分析(FEA)工具。本文将对这些工具进行详细介绍,帮助大家选择最贴合自身需求的解决方案。
SOLIDWORKS Simulation 不同版本的功能支持如下:

利用 SOLIDWORKS Simulation 套件获取热应力分析结果时,可采用的软件方案分为两类:基于 SOLIDWORKS Simulation 标准版的线性静力学分析,以及基于 SOLIDWORKS Simulation 高级版的非线性分析。
本文所采用的分析流程,将以 SOLIDWORKS 高级版作为获取应力结果的核心工具。具体流程为:先通过 SOLIDWORKS Simulation 专业版或 SOLIDWORKS Flow Simulation 流体仿真软件完成热分析并得到热分析结果,再将该结果导入结构分析模块,最终得到热应力分析结果。
一、热应力的产生原因
热应力的产生主要分为两种核心场景。第一种是不同热膨胀系数的零部件通过粘接连接所产生的应力。下图为两个粘接在一起的块状零件,二者热膨胀系数不同,且承受相同的热载荷,由此产生粘接应力。

标注热膨胀系数 0.002 的零件膨胀量更大,粘接面之间的膨胀量差异是热应力产生的根源。其中,热膨胀系数较小的粘接面会承受拉应力,热膨胀系数较大的粘接面则承受压应力,示意图中红色区域即为粘接应力的集中区域。
第二种产生热应力的场景是零件内部出现非均匀的温度分布。

左侧为承受热载荷的块状零件剖视图,可见零件中心区域温度最高,外侧区域温度较低。在热载荷和热膨胀系数的共同作用下,零件会从内部开始呈现出鼓胀式的膨胀变形,最终在零件上产生热应力,右侧示意图展示了该应力的分布状态。
二、热应力的探究思路
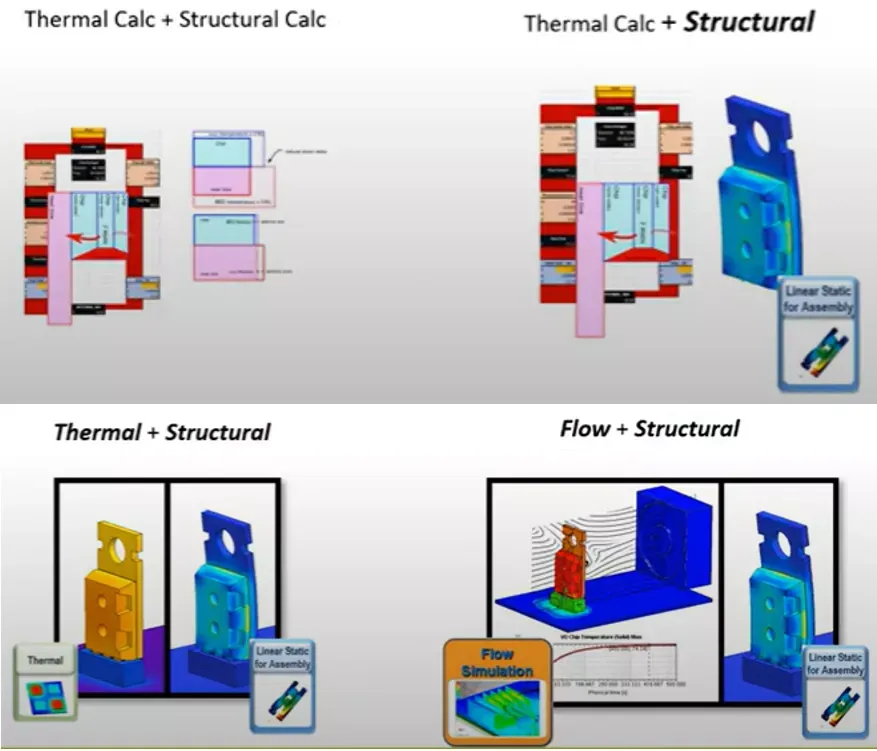
本次热应力分析将采用多种方法展开,从基础的手工计算法,逐步过渡到结合计算流体动力学(CFD)的高级仿真计算法,所有分析均围绕一个简易的陶瓷微芯片模型展开。

该模型的工况为:风扇向一个持续产生 3 瓦热量的陶瓷微芯片吹风,芯片产生的热量最终散发至周围空气中,本次分析的核心目标是计算微芯片与散热器接触区域的热应力分布。
三、热应力的两步判定法
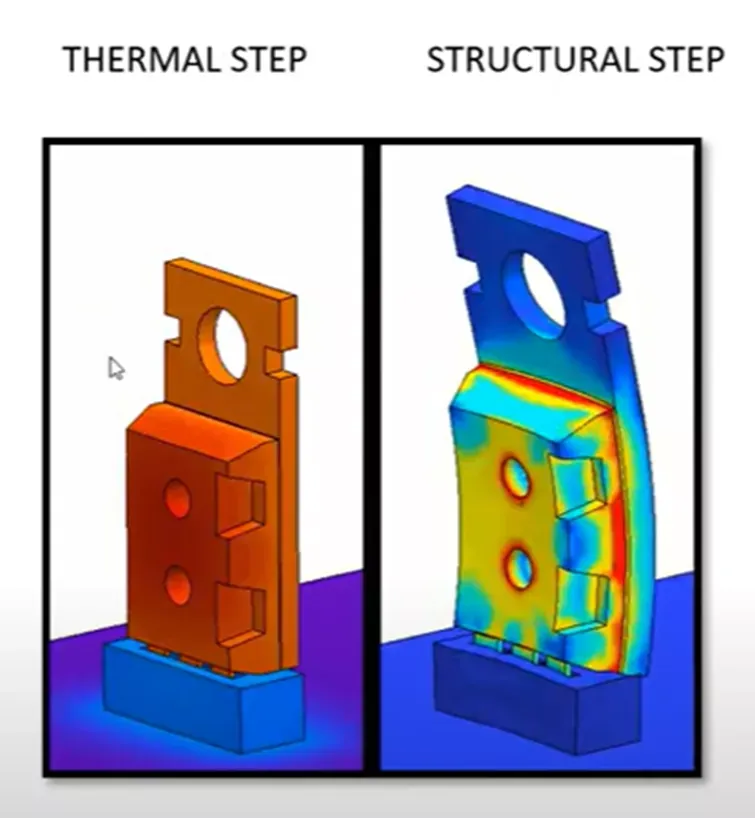
所有热应力分析均需遵循热分析步骤 + 结构分析步骤的两步法:
第一步(热分析):计算模型的热量传递规律和稳态温度分布;
第二步(结构分析):将热分析得到的温度数据代入结构分析模块,计算模型产生的热应力。
四、方法一:纯手工计算热应力
首先,我们采用纯手工计算的方式分析模型的热应力,该方法同样遵循上述两步分析流程,具体的手工计算过程和参数设置如下。
第一步:热分析 第二步:结构分析

以下是我们在手算中做出的一个主要假设。
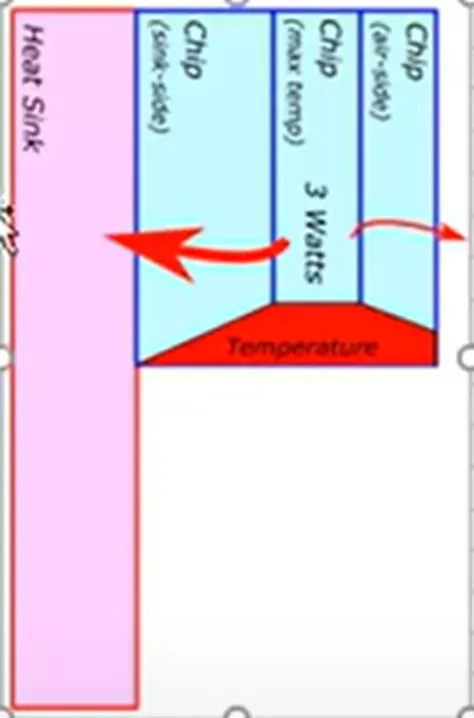
本次手工计算做出了以下关键假设:芯片产生的 3 瓦热量,绝大部分会通过芯片传递至散热器,再由散热器散发到空气中(示意图中红色大箭头),因为该传热路径的热阻最小;仅有小部分热量会直接由芯片散发至空气中
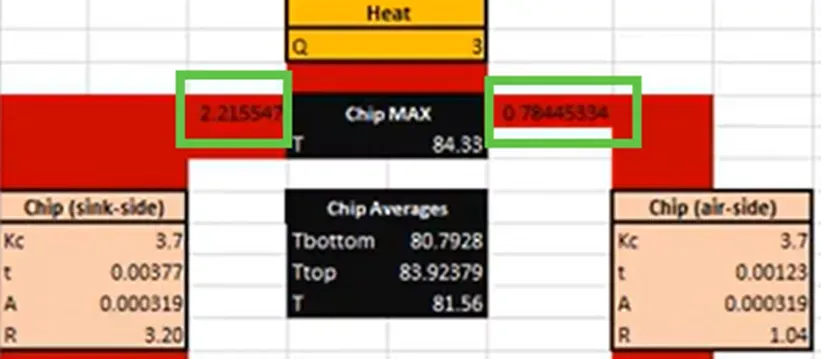
手工计算得出,芯片产生的 3 瓦热量中,约 2.2 瓦(占比 3/4)会向左传递至散热器,剩余约 0.8 瓦(占比 1/4)会直接向右散发至周围空气。
手工计算的另一核心假设为确定 3 瓦热量向空气传递的效率,即明确散热器到空气、芯片直接到空气这两条路径的对流换热系数,相关计算参数在表格中以橙色单元格标注。

对于一般情况,你可以在网上找到推荐对流系数的表格(如下图):
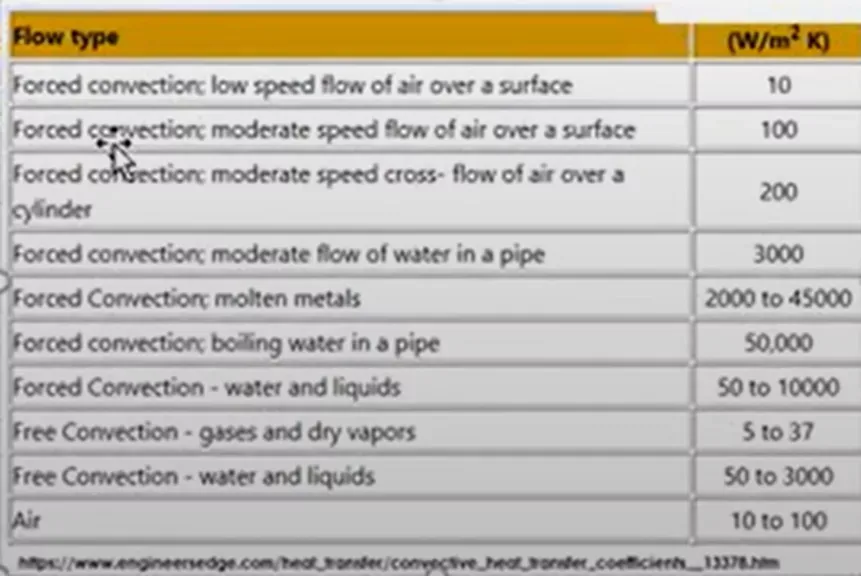
本次分析的流态与上表中前两种空气受迫对流最接近,因此需在 10~100 W/(m²・K) 的范围内选取贴合实际工况的数值,该数值的选择对计算结果影响显著,需谨慎确定。

当选取对流换热系数为 50 W/(m²・K) 时,芯片最高温度为 84.3℃;当选取系数为 100 W/(m²・K) 时,芯片最高温度大幅降至 64.1℃。本次示例将统一采用 50 W/(m²・K) 作为对流换热系数。
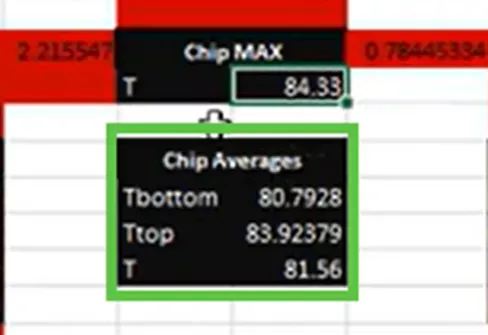
将热分析得到的温度汇总结果代入结构分析,进行手工计算,步骤如下:
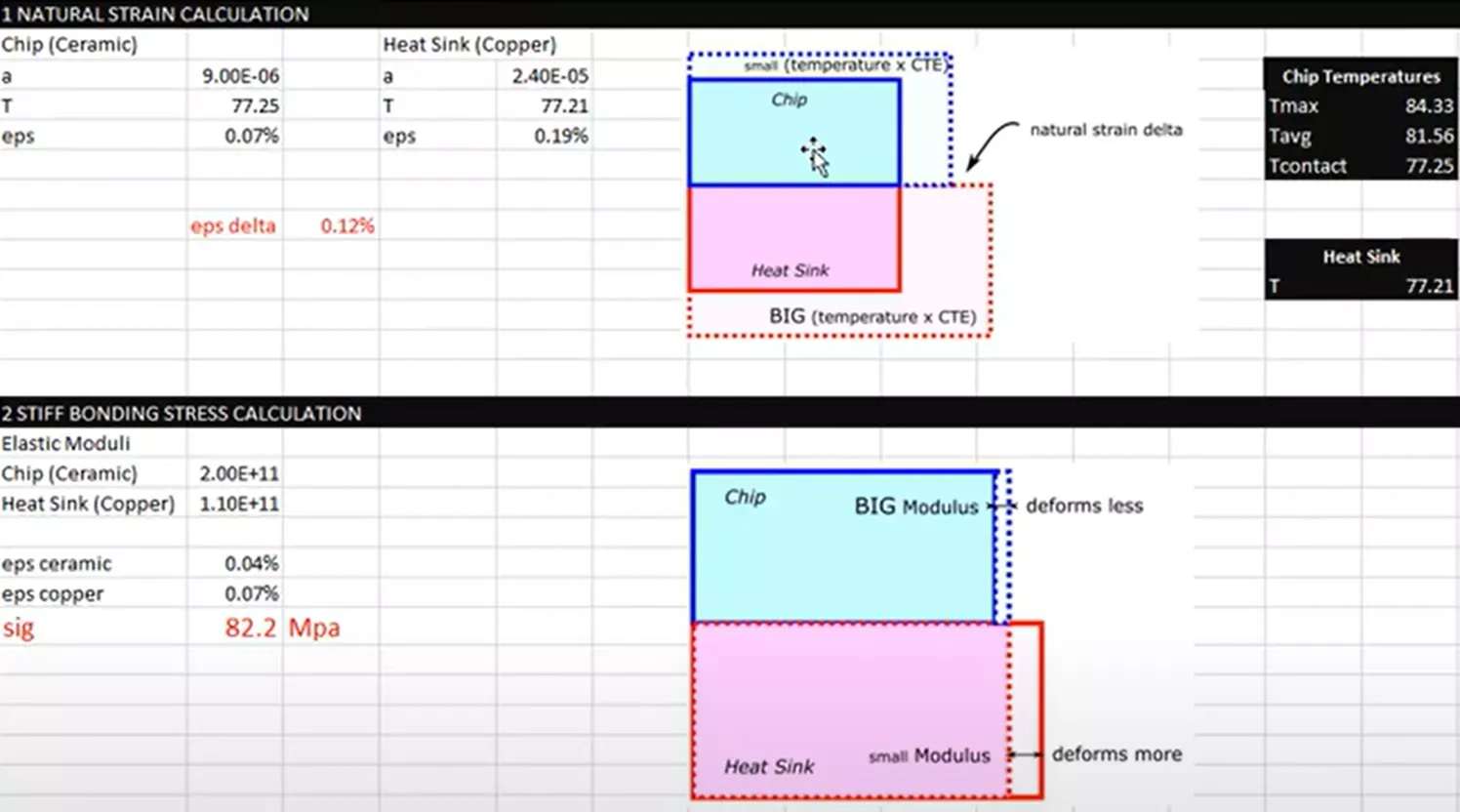
在结构层面,我们需要考虑两个物体在热载荷下的膨胀。

如前所述,当物体连接或结合时,应力开始产生。
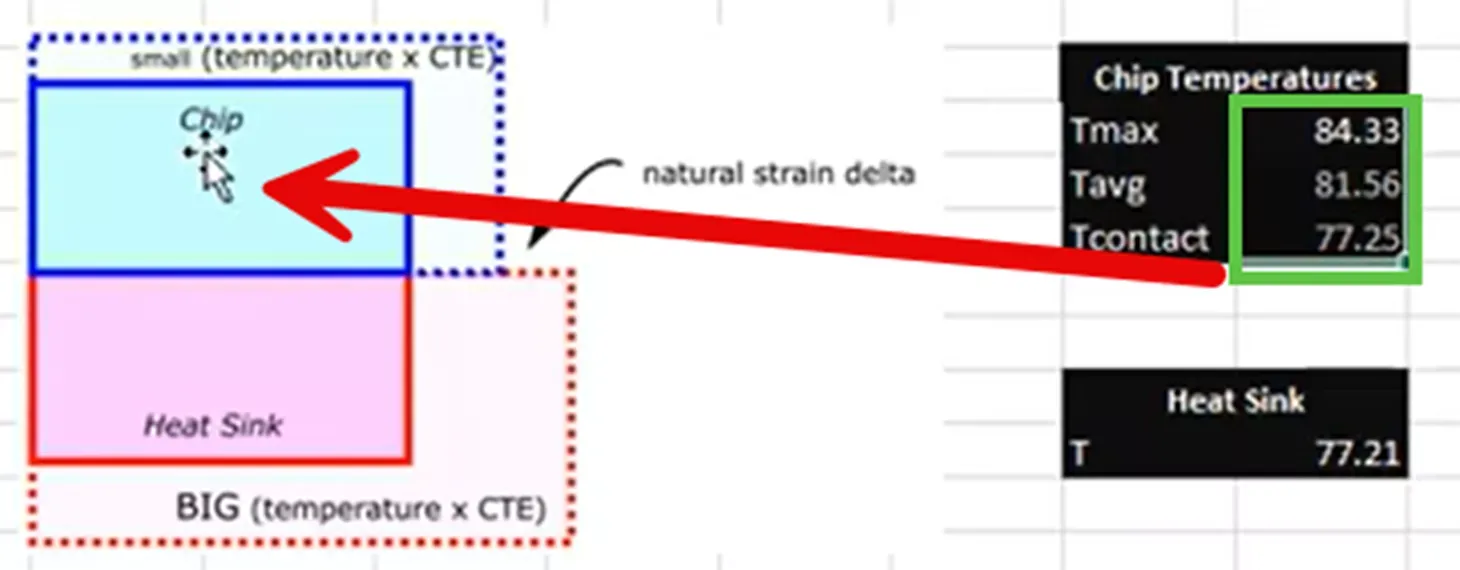
手工计算得出芯片存在多个温度值(绿色标注),原因是芯片中心温度高、外侧温度低。在结构手工计算中,需遵循最保守原则选取温度:由于芯片与散热器粘接,要计算最大热应力,需假设芯片膨胀量最小、散热器膨胀量最大,因此选取芯片的最低温度(77.25℃)和散热器的最高温度进行计算,以得到最保守的应力结果。
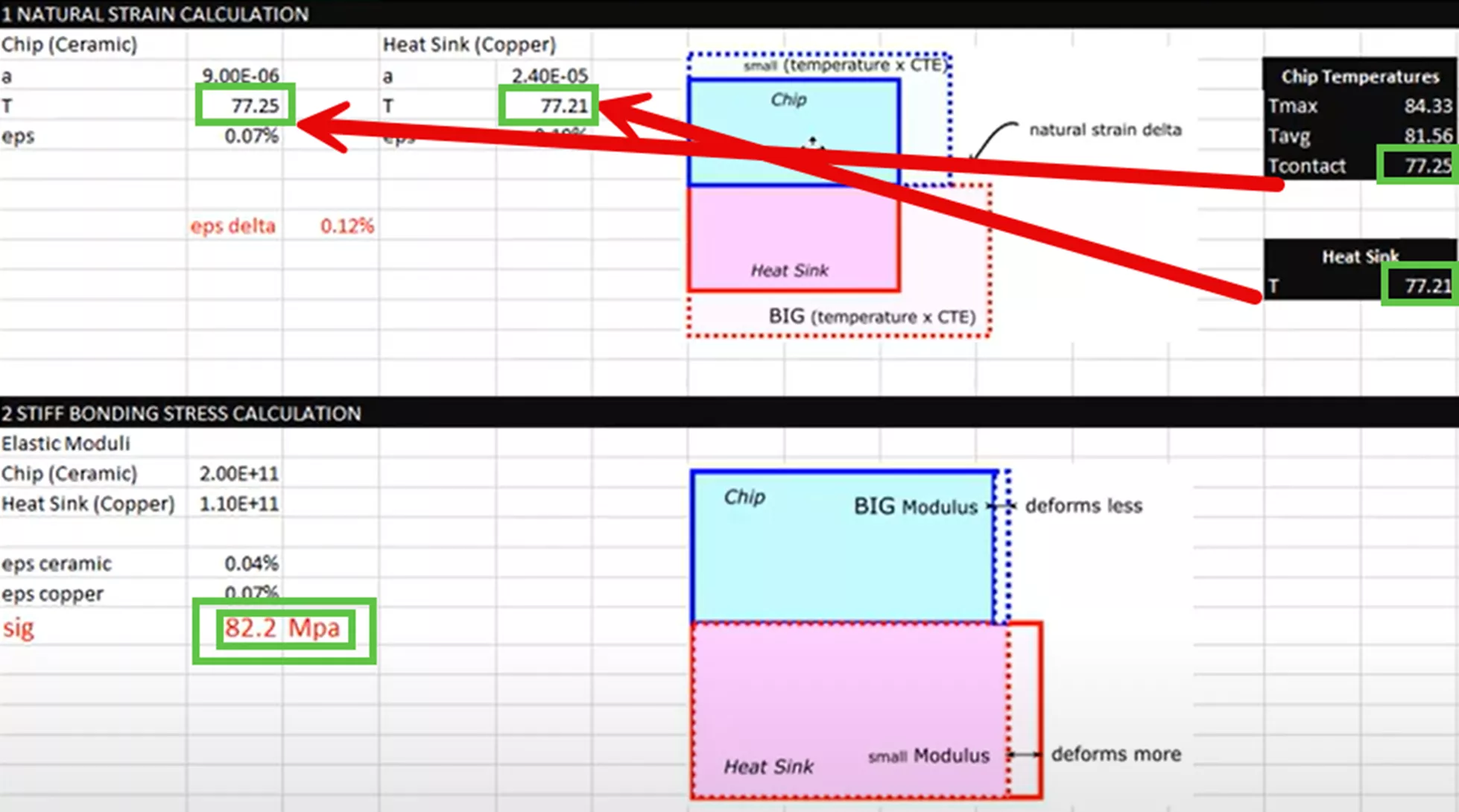
本次纯手工计算最终得到芯片与散热器的接触应力为 82.2 MPa,计算过程中针对热分析和结构分析均做出了大量假设,具体如下:
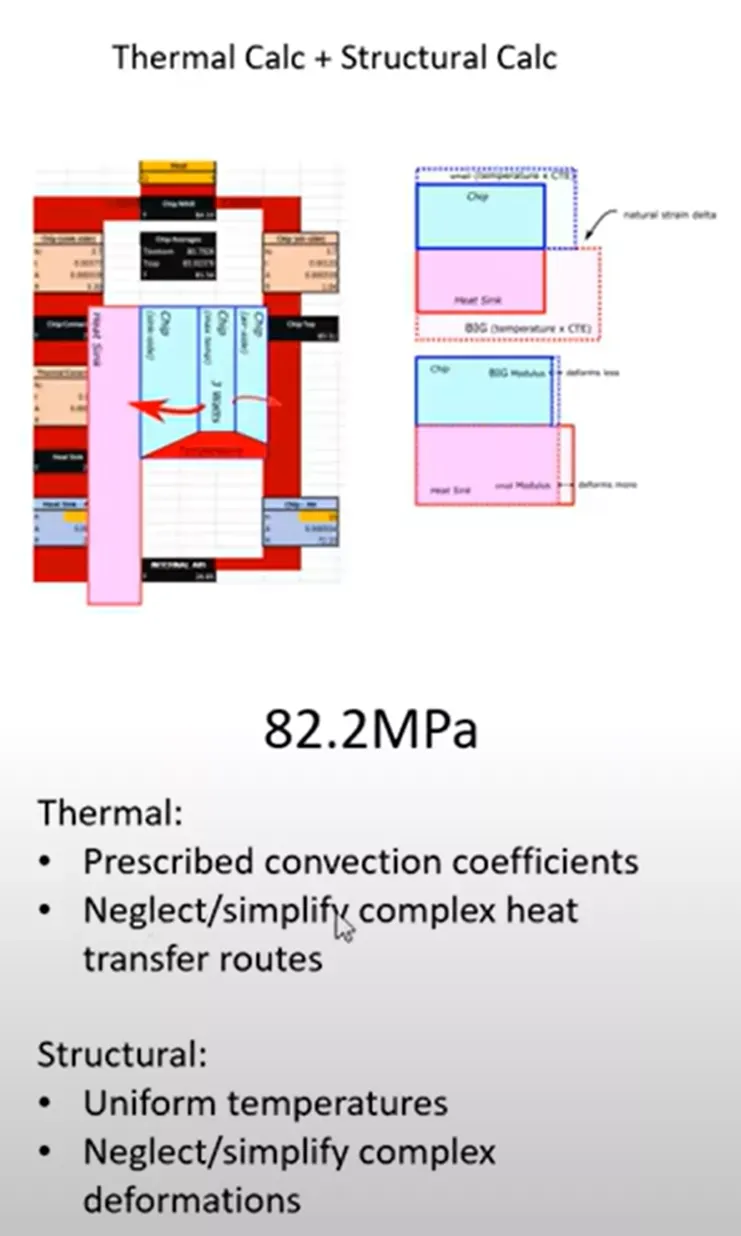
其中,对流换热系数的人为选取和芯片至印刷电路板(PCB)、散热器的复杂传热路径简化是本次手工计算最主要的假设,计算中直接忽略了部分次要传热路径的影响。
五、方法二:手工计算传热,SOLIDWORKS Simulation 计算应力
第一步:热分析(手工计算) 第二步:结构分析(SOLIDWORKS Simulation 装配体线性静力学分析)
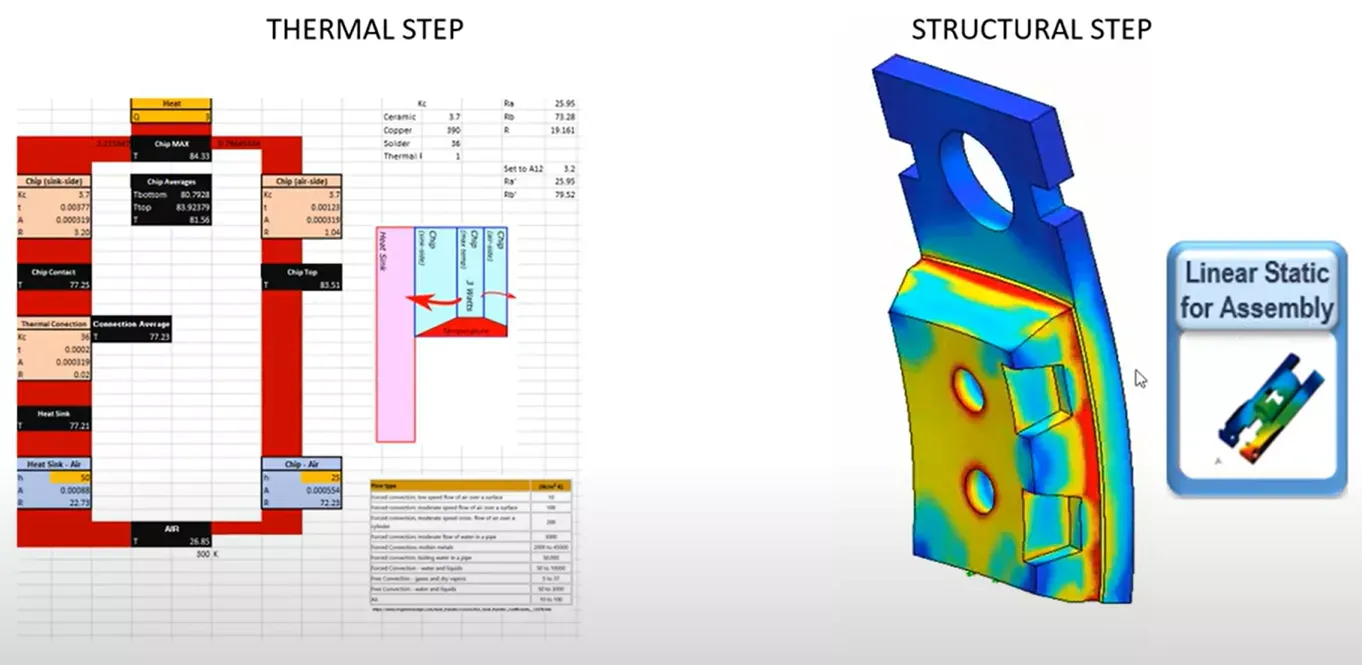
本方法将对分析结果进行优化,保留热分析的手工计算过程,将结构分析步骤替换为 SOLIDWORKS Simulation 仿真计算,结构分析将采用 SOLIDWORKS Simulation 标准版的静力学结构分析工具,热载荷则直接采用手工计算得到的温度数据。
1. 模型简化
在 SOLIDWORKS 中打开模型,由于手工计算未得到印刷电路板(PCB)和连接器的温度数据,因此将模型简化为微芯片 + 散热器的组合模型。
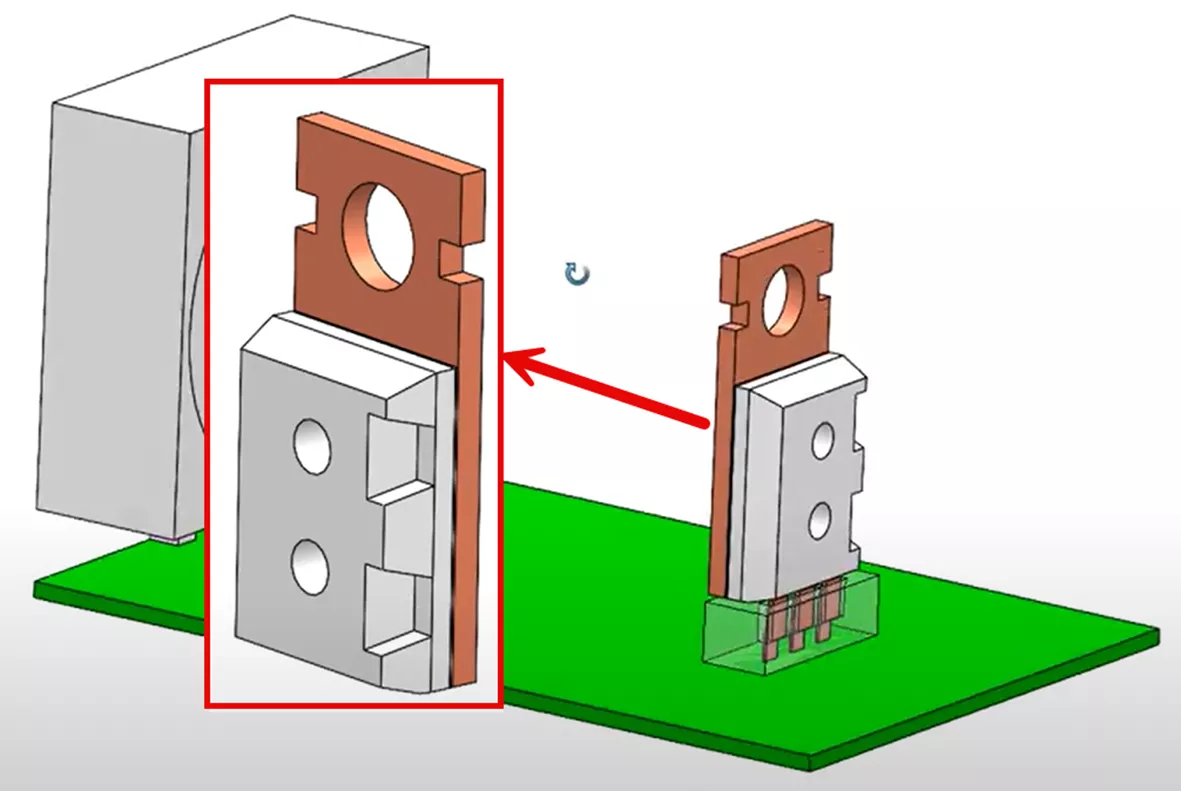
2. 创建静力学分析研究
在 SOLIDWORKS 中新建静力学分析研究,命名为 “Standard Static (-ChipSink-)”,分析树包含以下核心模块:零部件、连接关系、零部件相互作用、夹具、外部载荷、网格、结果选项。
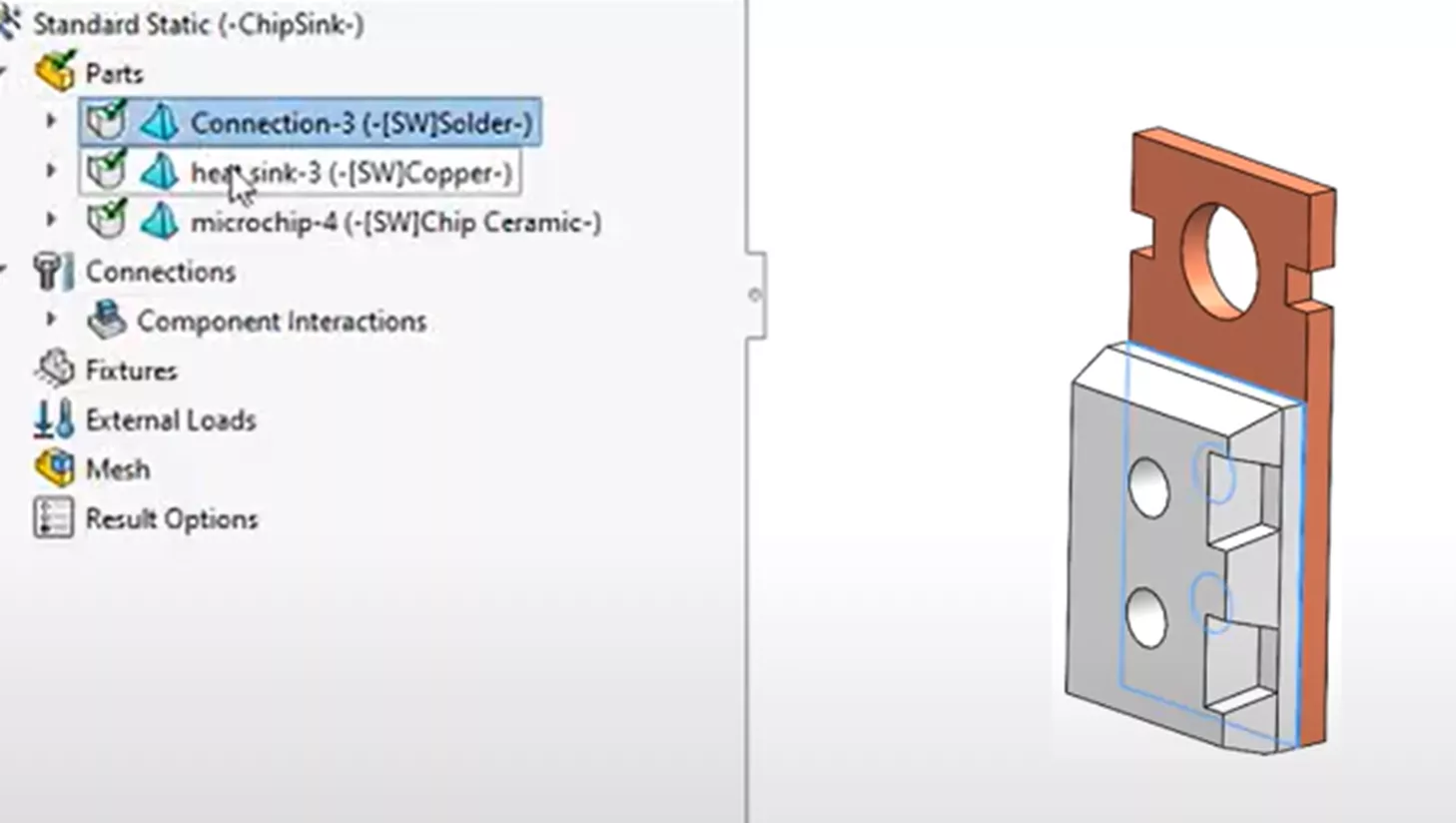
3. 材料分配
CAD 模型已为各零部件分配材料,且该属性已同步至仿真分析中:芯片与散热器之间的薄胶层为焊料、散热器为铜、微芯片为陶瓷。
4. 零部件相互作用设置
采用全局绑定接触,即假设所有初始接触的几何面均为粘接连接。

5. 夹具边界条件设置
为了在三维空间中固定并稳定模型,本次先对选定的芯片表面施加滑移支撑边界条件,后续可尝试其他边界条件进行对比分析。
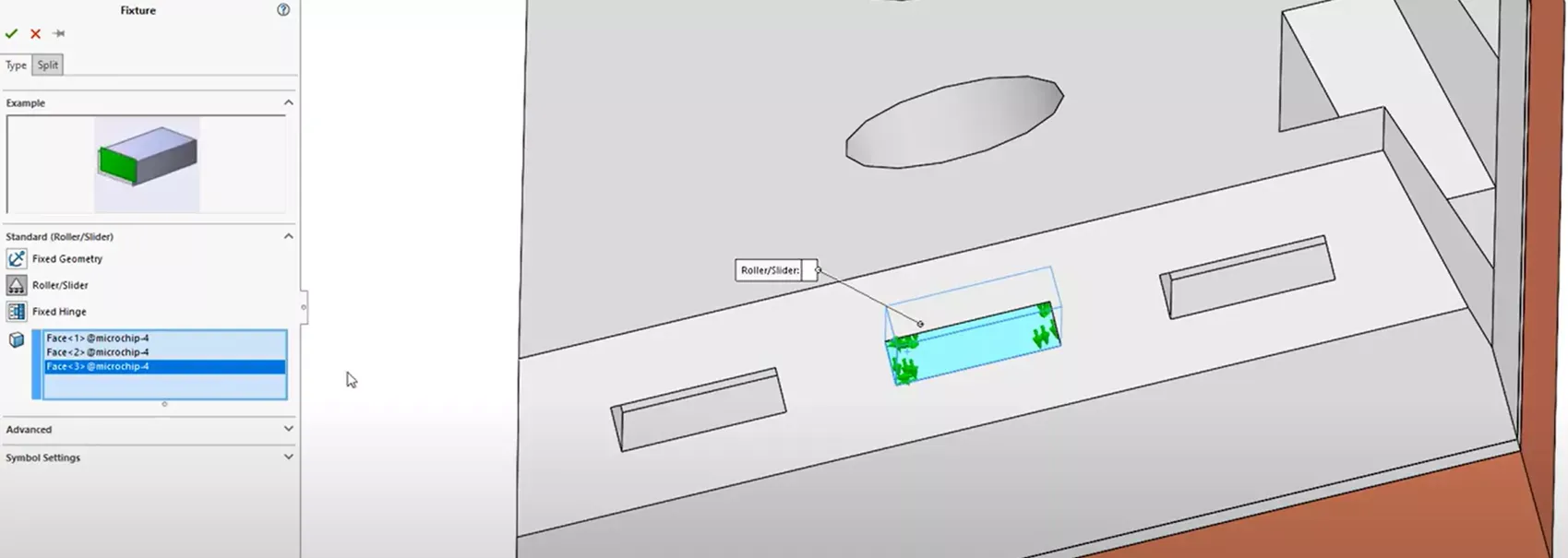
6. 热载荷施加
将手工计算得到的温度数据作为热载荷施加至芯片和散热器,同时假设焊料的温度与芯片一致,具体参数:
芯片温度:77.25℃,热膨胀系数 9×10^-6 K^-1
散热器温度:77.21℃,热膨胀系数 24×10^-6 K^-1
操作方式:在 “外部载荷” 中选择 “温度”,分别为芯片和散热器的所有外露面分配对应温度值。


7. 零应变参考温度设置
在研究属性中,进入 “流体 / 热效应” 选项卡,设置零应变参考温度为 300 开尔文(约 80.33 华氏度),该温度为分析中所有未单独指定初始温度的零部件的默认初始温度。


8. 网格划分与仿真求解
采用混合曲率网格划分策略对模型进行离散化网格划分,完成后运行仿真求解,得到接触热应力的分布结果。

仿真结果与分析
仿真结果显示,散热器的热膨胀量大于陶瓷芯片,因此在二者的粘接区域产生热应力,且散热器向左侧发生弯曲变形。对芯片接触面上的平均应力进行测量,得到结果为86.42 MPa。

该结果与手工计算的 82.2 MPa 高度接近,且仿真计算考虑了零部件的实际几何形状和变形响应,相比手工计算的大量假设,结果更贴合实际。
方法二的假设与结果总结
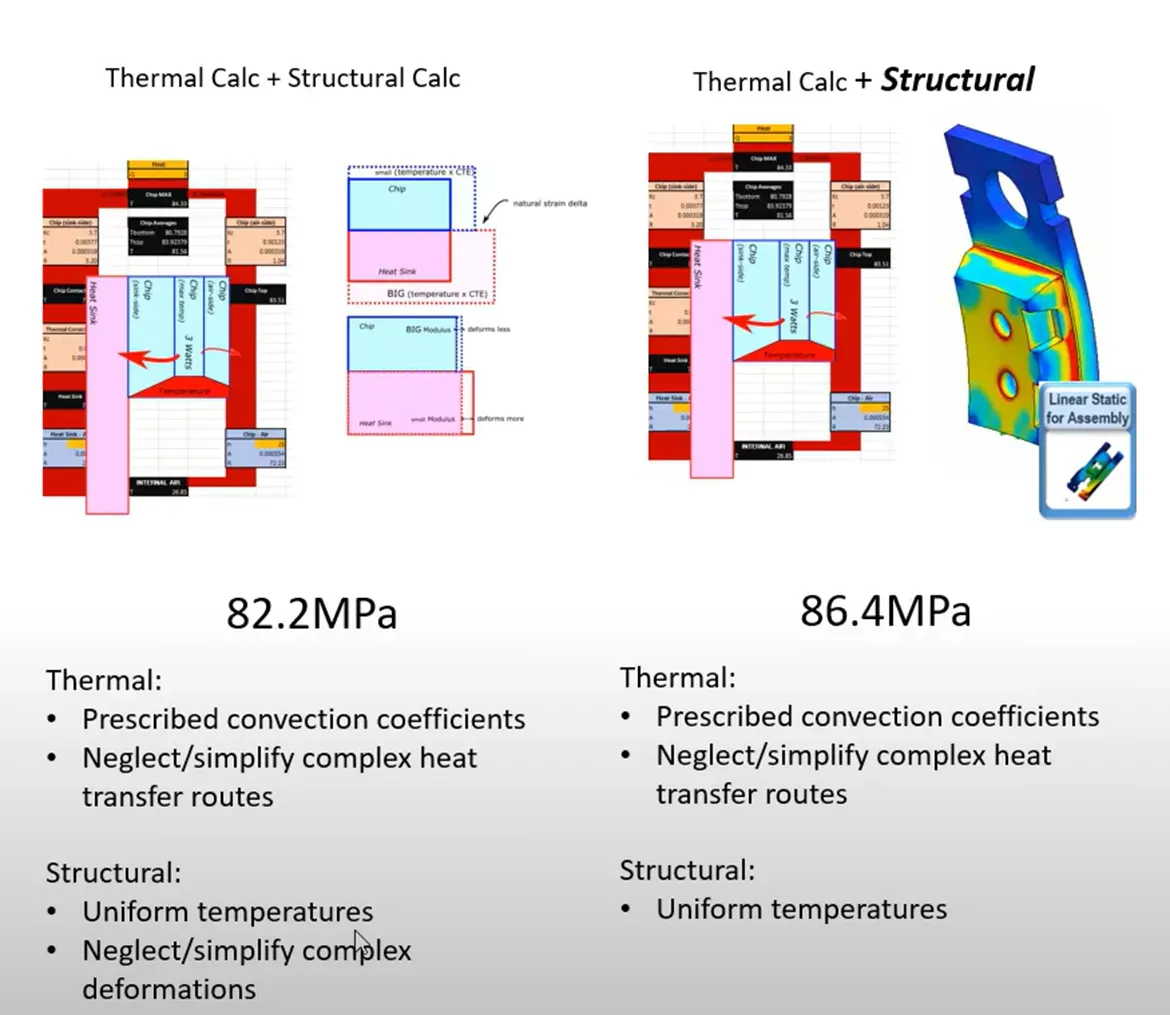
六、方法三:全程使用 SOLIDWORKS Simulation 计算

本方法将完全摒弃手工计算,全程采用 SOLIDWORKS Simulation 仿真工具:通过 SOLIDWORKS Simulation 专业版完成热分析,得到模型的温度分布(可精准体现非均匀温度梯度);

结构分析步骤与方法二一致,但将加入连接器的几何细节,使分析更完整。

第一步:热分析(SOLIDWORKS Simulation 专业版) 第二步:结构分析(SOLIDWORKS Simulation 装配体线性静力学分析)
热分析的设置与操作

新建热分析研究:在 SOLIDWORKS 中新建热分析研究,命名为 “Pro Thermal (-Default-)”,分析树包含:零部件、连接关系、零部件相互作用、热载荷、网格、温度、对流、热通量、热功率、辐射、选项。
施加热功率载荷:选取微芯片的整个实体,施加3 瓦的热功率载荷,作为芯片的热量来源。

施加对流边界条件:
主对流:对散热器和底部连接器的所有外露面施加对流,对流换热系数 50 W/(m²・K),环境体温度 300 开尔文,与手工计算保持一致;

二次对流:对芯片的外露面施加对流,由于陶瓷的传热效率低,选取更低的对流换热系数 25 W/(m²・K),环境体温度 300 开尔文;
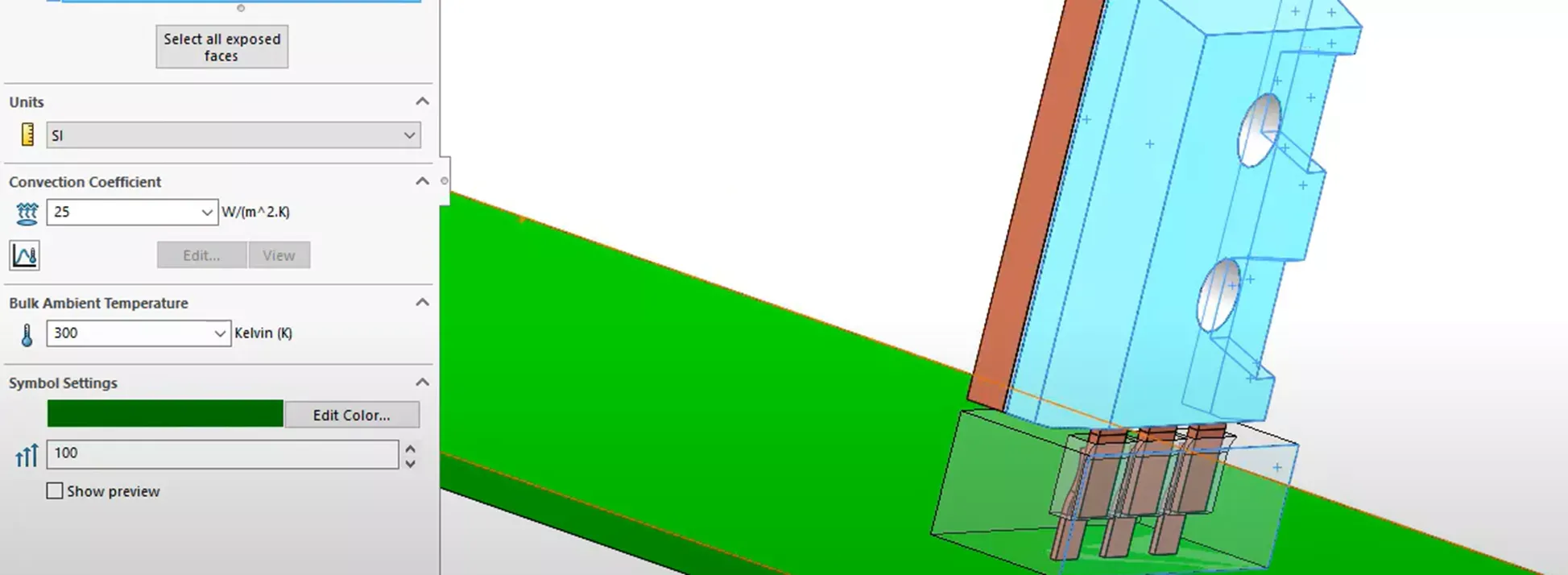
三次对流:对印刷电路板(PCB)的表面施加对流,对流换热系数 10 W/(m²・K),环境体温度 300 开尔文。

零部件相互作用设置:
全局绑定:选取芯片、导热膏、散热器、铜连接器,设置为全局绑定接触,保证热量在各部件间的正常传递;

二级绑定:选取印刷电路板、连接器、三根引脚,同样设置为绑定接触;

局部热阻:芯片铜连接器与连接器引脚的接触区域存在类弹簧特性的接触,且接触面粗糙会产生额外热阻,因此对该接触区域设置局部热阻,分布式热阻值为 0.01 (K・m²)/W;同时在芯片连接器与连接器外壳之间也设置相同的局部热阻。
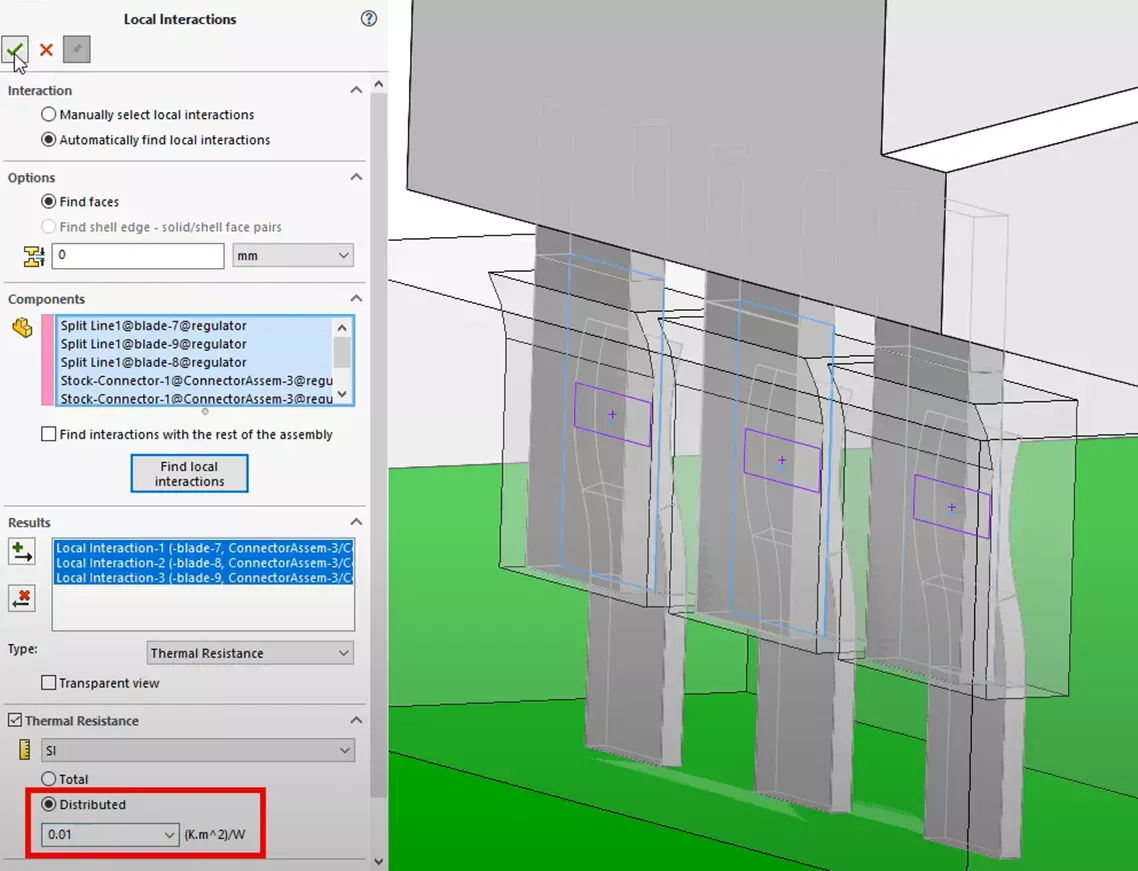
网格划分与仿真求解:采用与方法二相同的网格设置对模型进行划分,完成后运行仿真求解。
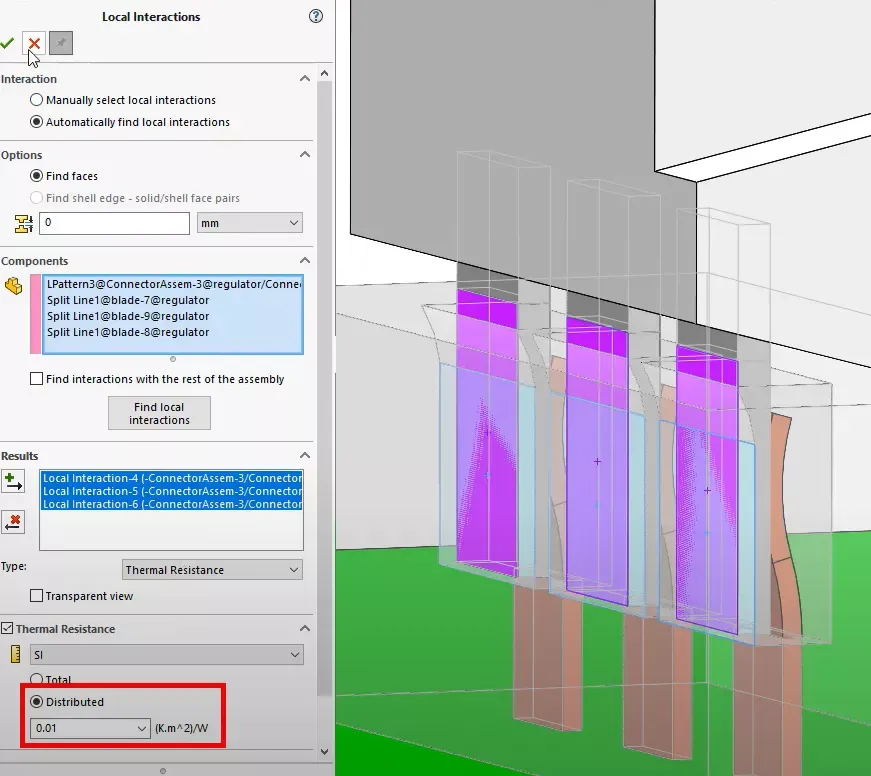
热分析结果
仿真得到的温度云图显示,模型的最高温度为82.33℃,并可清晰观察到整个模型的温度梯度分布。
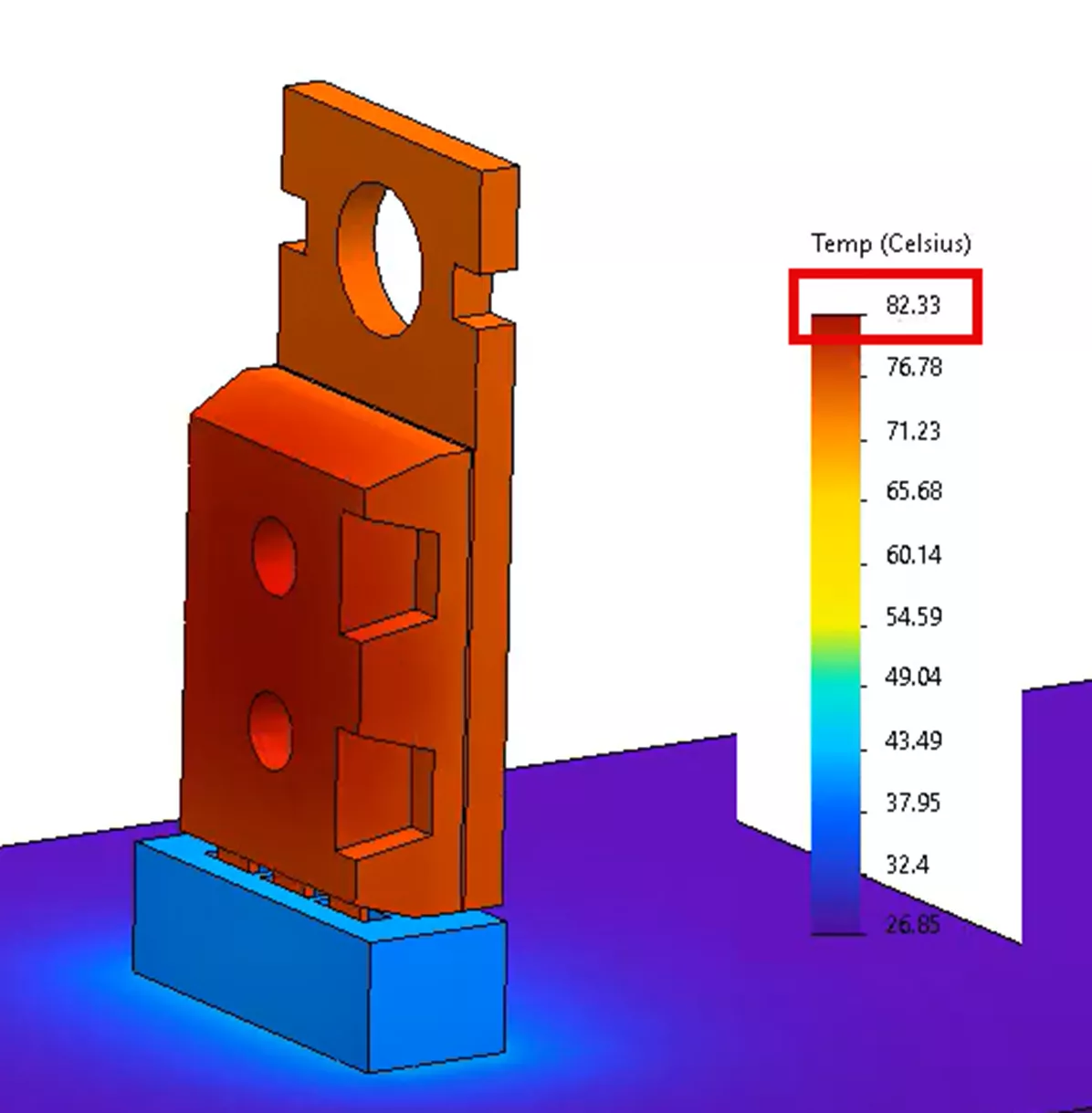
通过后处理工具 “列出热功率” 计算芯片至散热器的传热量,得到实际传热量为2.06 瓦,与手工计算的 2.2 瓦接近。
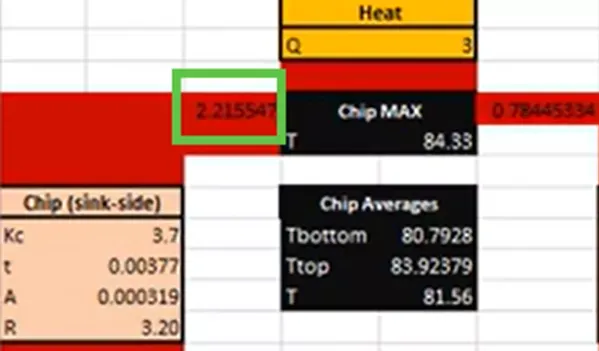
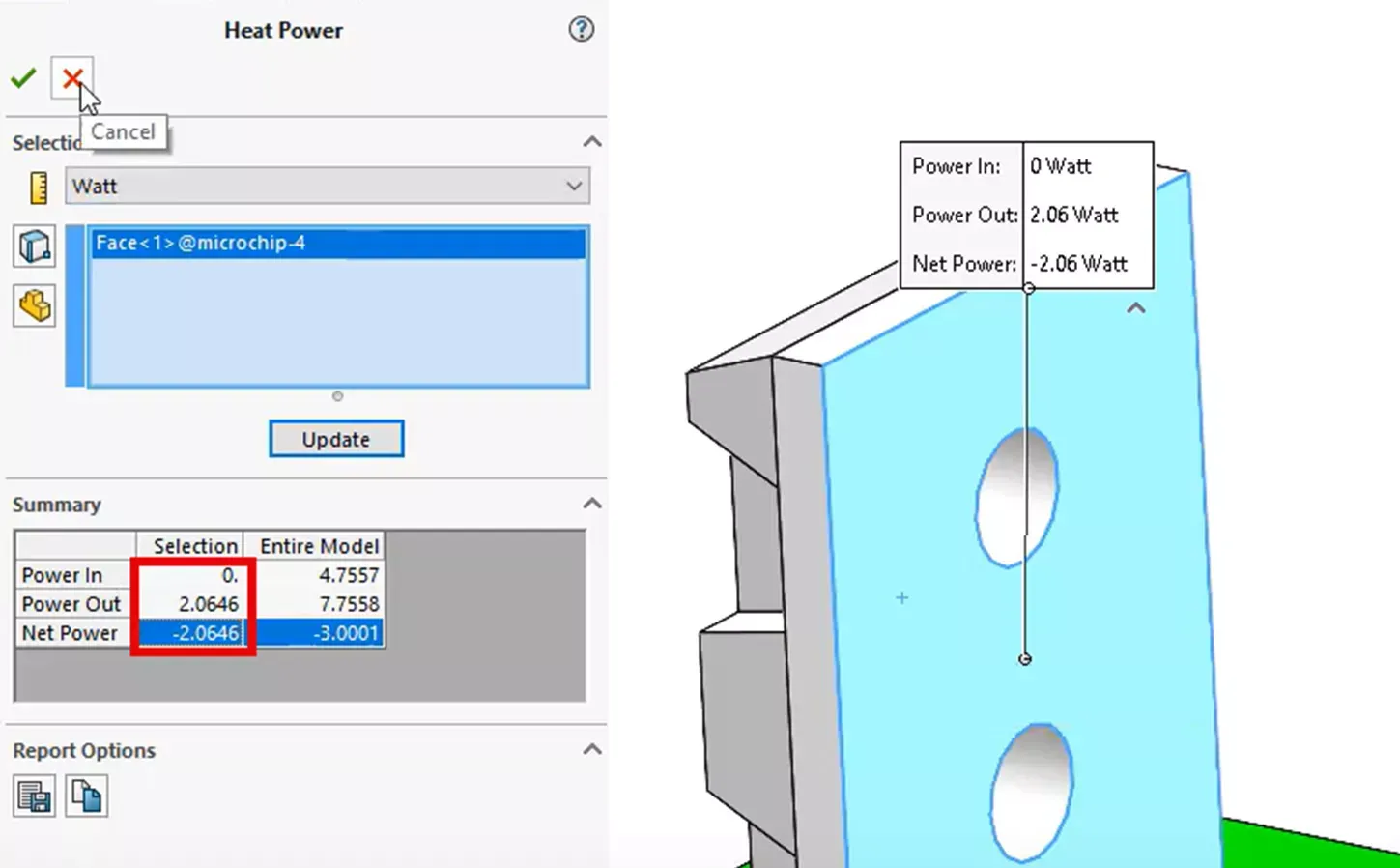
结构分析的设置与操作
新建静力学分析研究:采用与方法二完全相同的方式新建静力学分析研究,因模型加入了更多几何细节,在连接器的相互作用中加入摩擦系数(取值 0.1),使接触设置更精准。

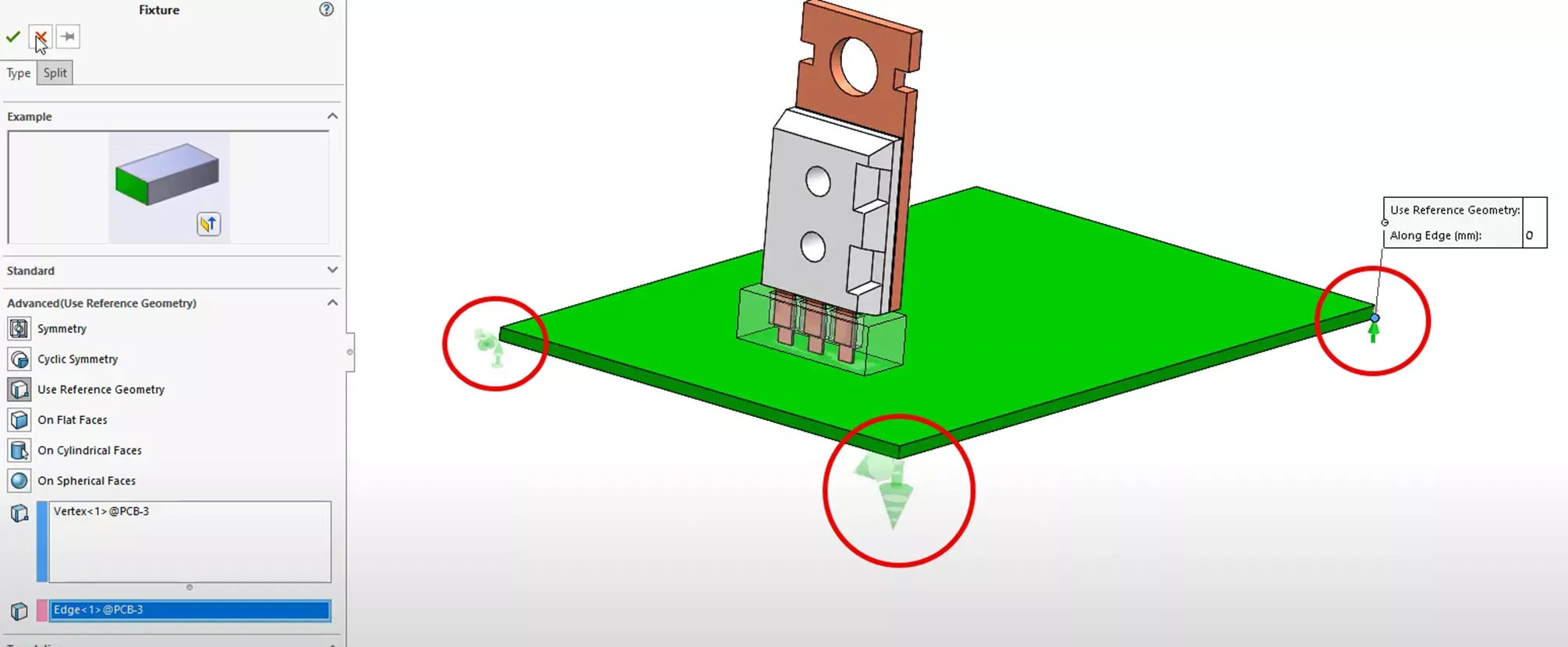
夹具边界条件优化:由于模型加入了印刷电路板,本次施加三个夹具特征限制电路板的自由度,保证其在计算中既稳定又能产生正常的变形。
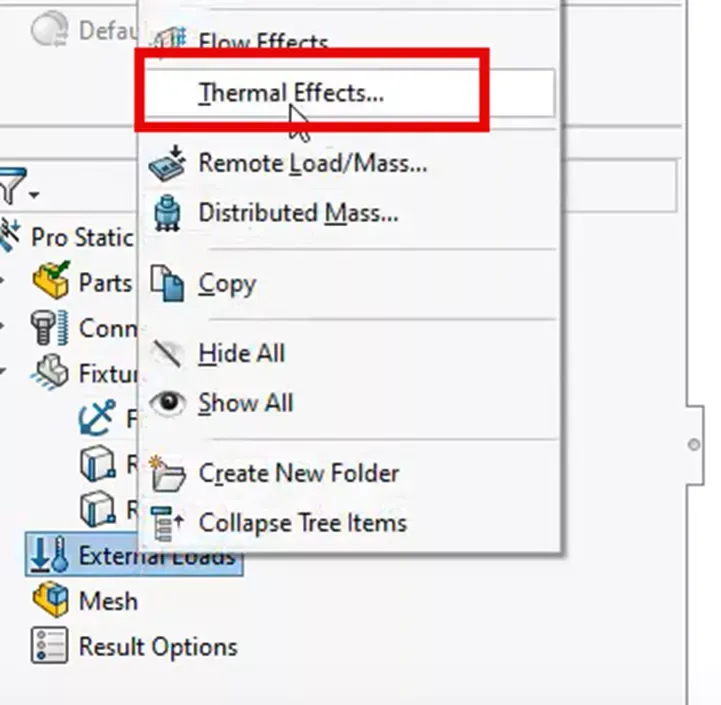
导入热分析结果:在仿真设计树的 “外部载荷” 中选择 “热效应”,在弹出的研究属性窗口中,勾选 “从热分析研究导入温度”,并在下拉菜单中选择上述热分析研究 “Pro Thermal”,同时设置零应变参考温度为 300 开尔文。
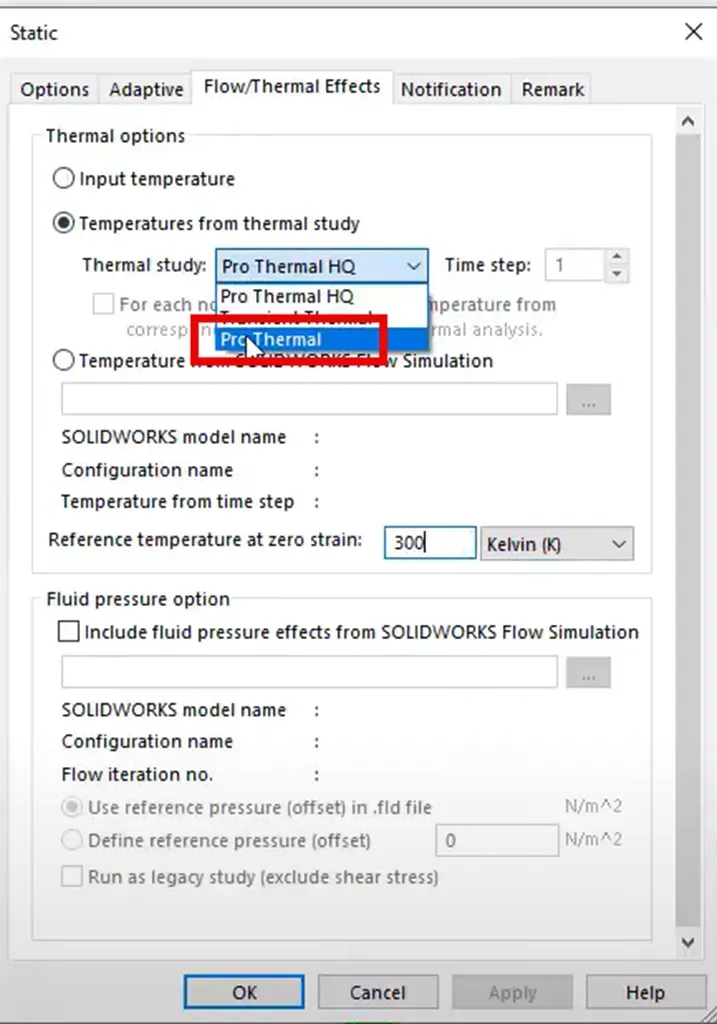
网格划分与仿真求解:采用相同的曲率网格划分策略,运行仿真求解。
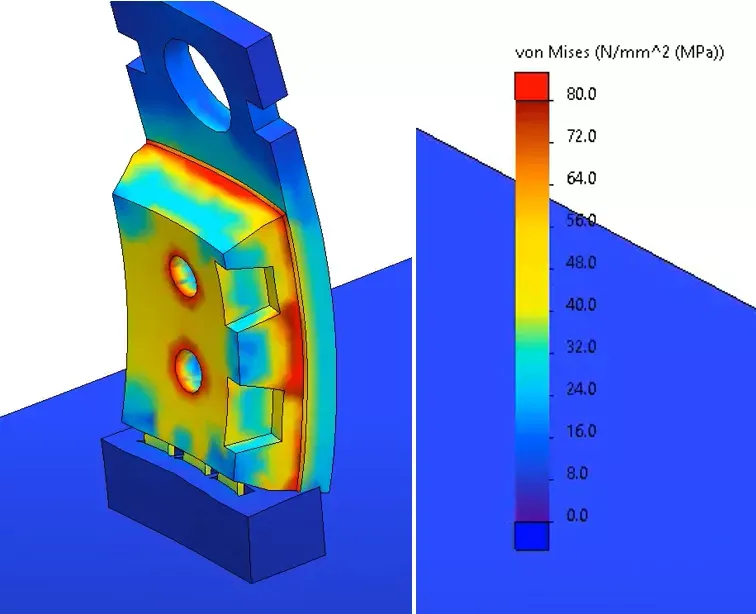
结构分析结果
导入温度后的应力云图显示,模型的应力梯度分布与方法二相似,对芯片同一接触面上的平均应力进行测量,得到结果为91.84 MPa。
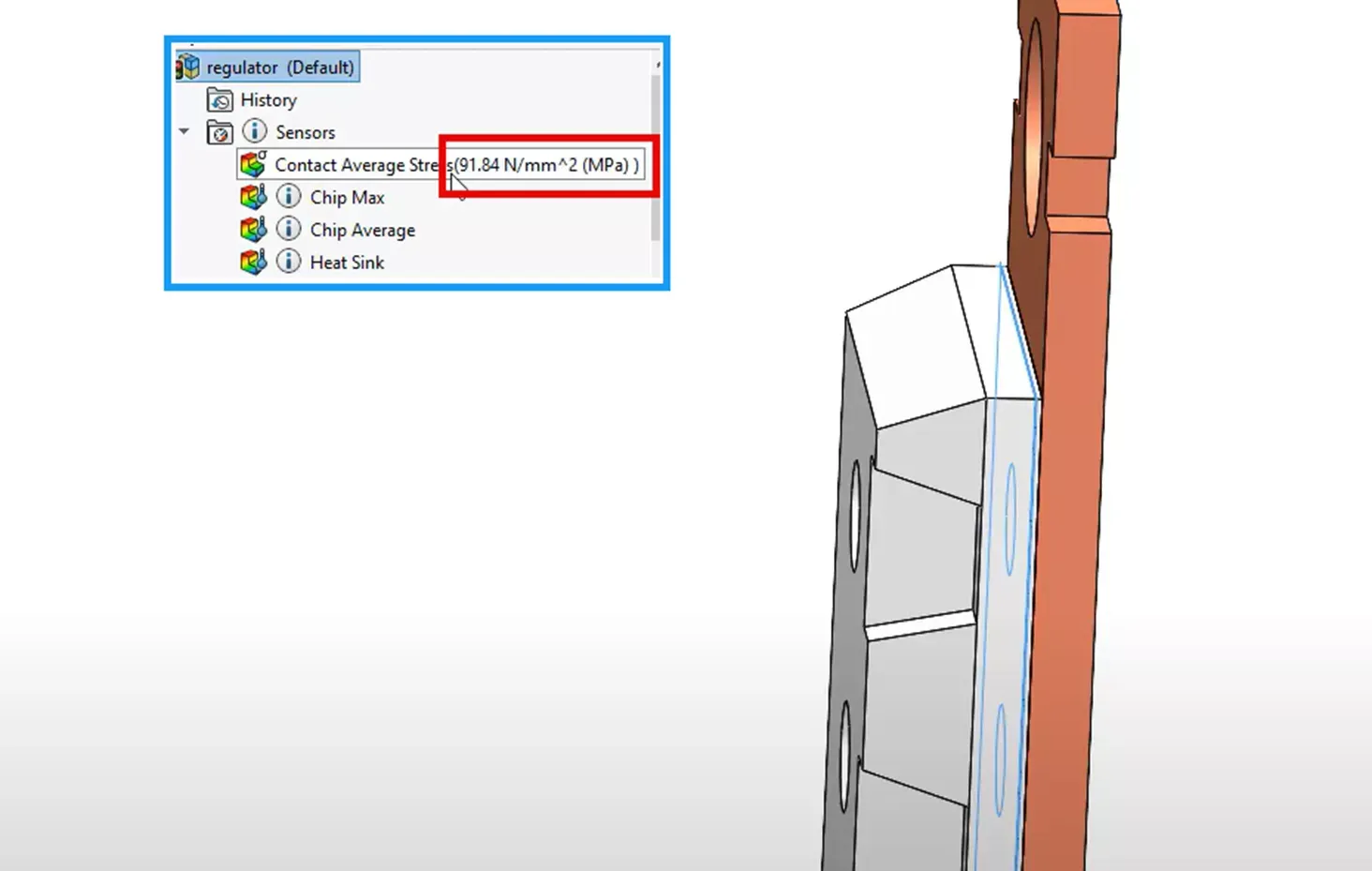
方法三的结果与优势分析
该结果是目前最精准的热应力值,原因是本方法的假设条件大幅减少,相比前两种方法有以下核心优化:
热分析不再假设零件温度均匀分布,可计算出芯片内部更贴合实际的高温区,且能体现从芯片形心向外逐渐降低的温度梯度;
利用零部件的实际几何形状计算复杂传热路径,得到更精准的热通量;
热分析中对接触区域的热阻进行了精准建模,这些优化均使接触区域的应力计算更贴合实际。
方法三的假设与结果总结
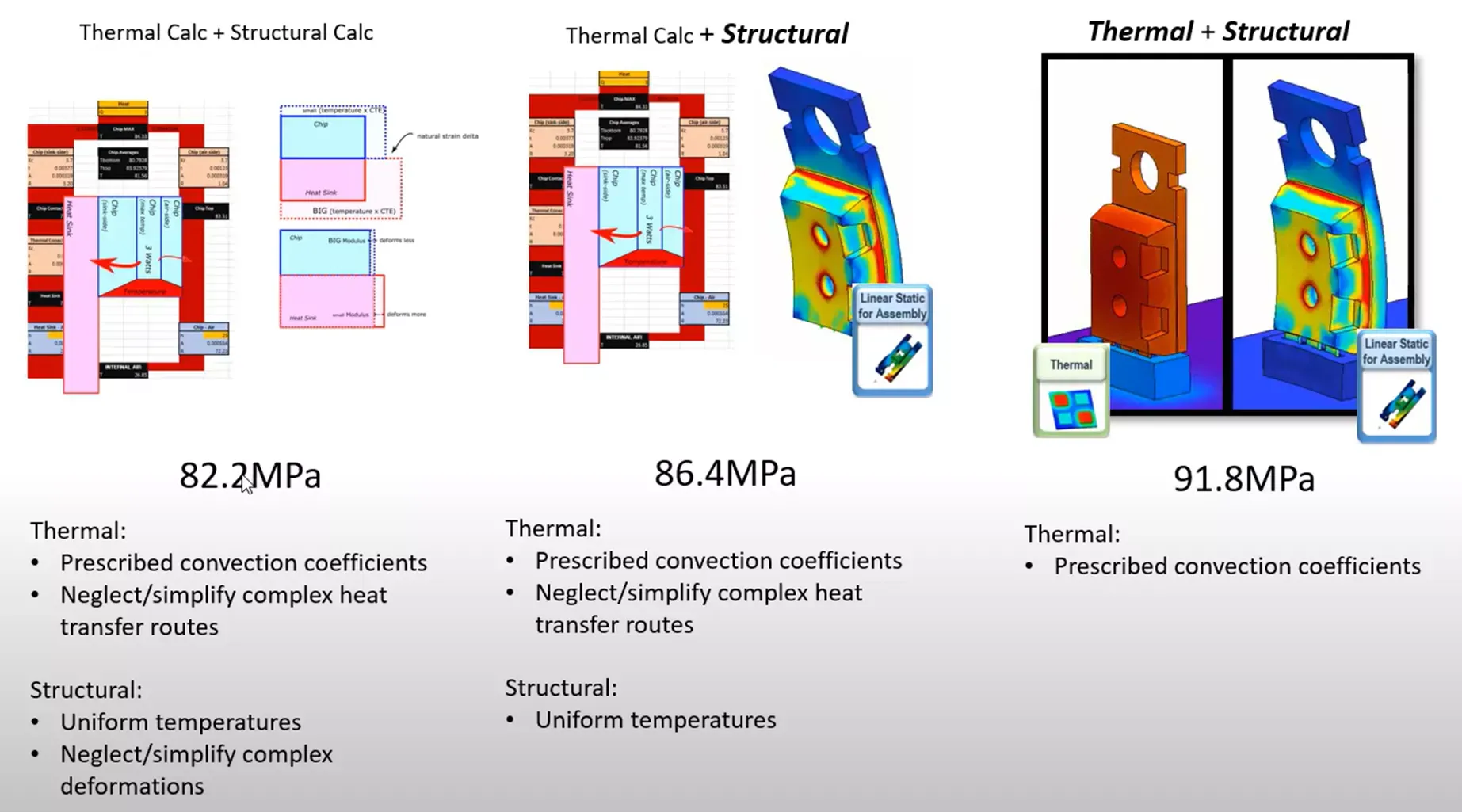
七、方法四:SOLIDWORKS Flow Simulation 计算传热,SOLIDWORKS Simulation 计算结构应力
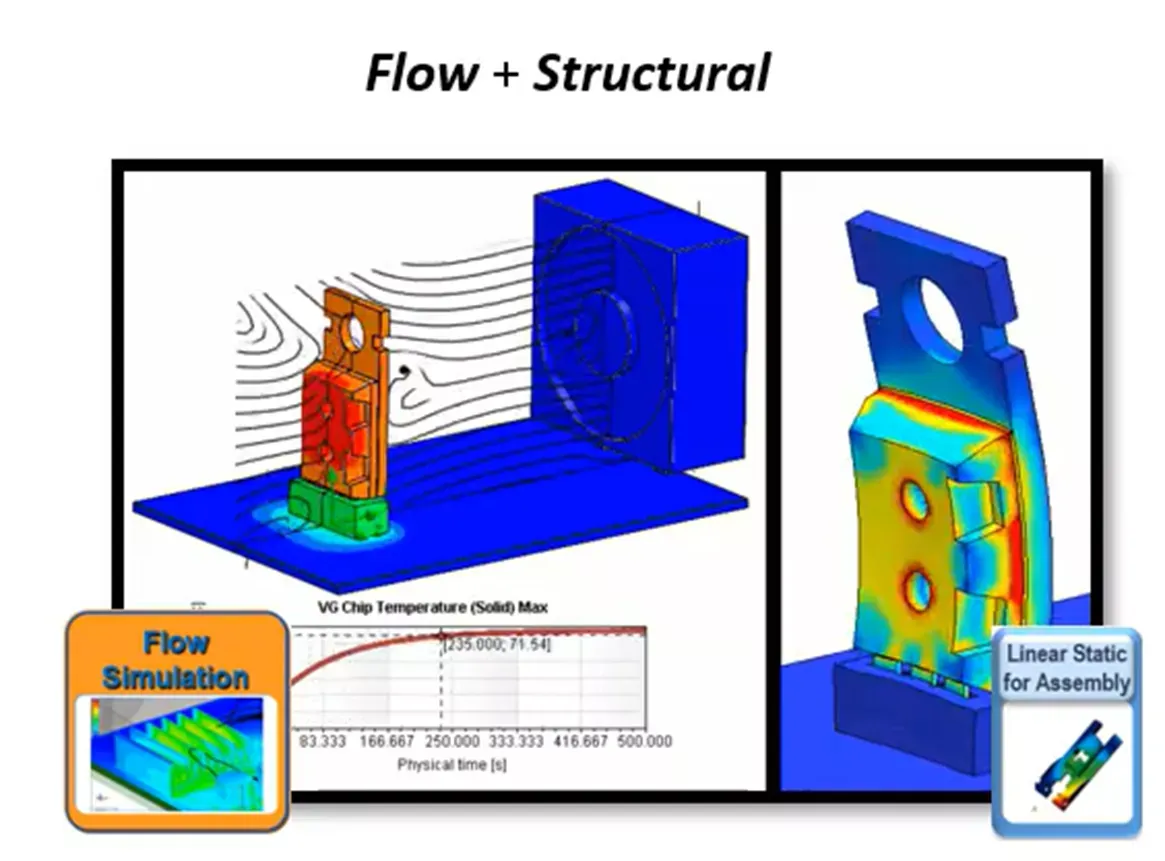
本方法将采用 SOLIDWORKS Flow Simulation 流体仿真软件完成热分析步骤,该软件可自动计算对流换热系数,无需人工估算,从根源上减少热分析的假设条件;结构分析仍采用 SOLIDWORKS Simulation 有限元分析工具,最终将流体仿真得到的高精度热分析结果导入结构分析模块。
SOLIDWORKS Flow Simulation 专注于流体动力学和传热仿真,可对热系统的更多影响因素进行分析,本文将详细介绍该软件的操作流程,以及如何将其得到的精细化热分析结果导入 SOLIDWORKS Simulation 进行结构应力计算。
第一步:热分析(SOLIDWORKS Flow Simulation) 第二步:结构分析(SOLIDWORKS Simulation 装配体线性静力学分析)

在原有热模型的基础上加入风扇部件,模拟风扇向芯片吹风的工况,使热分析可精准体现芯片表面的受迫对流效应。
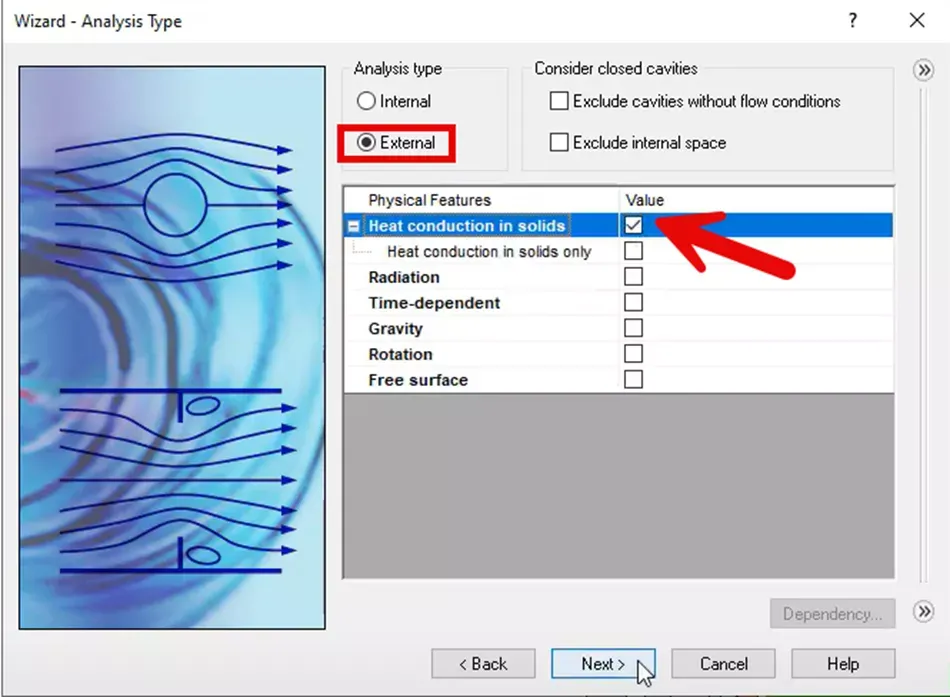
流体仿真的设置与操作
新建外部流体仿真项目:
分析类型:选择外部分析,不考虑封闭腔室,排除无流动的腔室空间;
物理特征:开启固体热传导功能,默认流体介质为空气;
临时材料:向导中先将默认材料设为 “绝缘体”,后续将通过本地选择覆盖材料定义;

初始与环境条件:设置初始温度为 300 开尔文,与手工计算保持一致,方便结果对比;环境压力为 101325 帕,初始速度为 0 m/s。
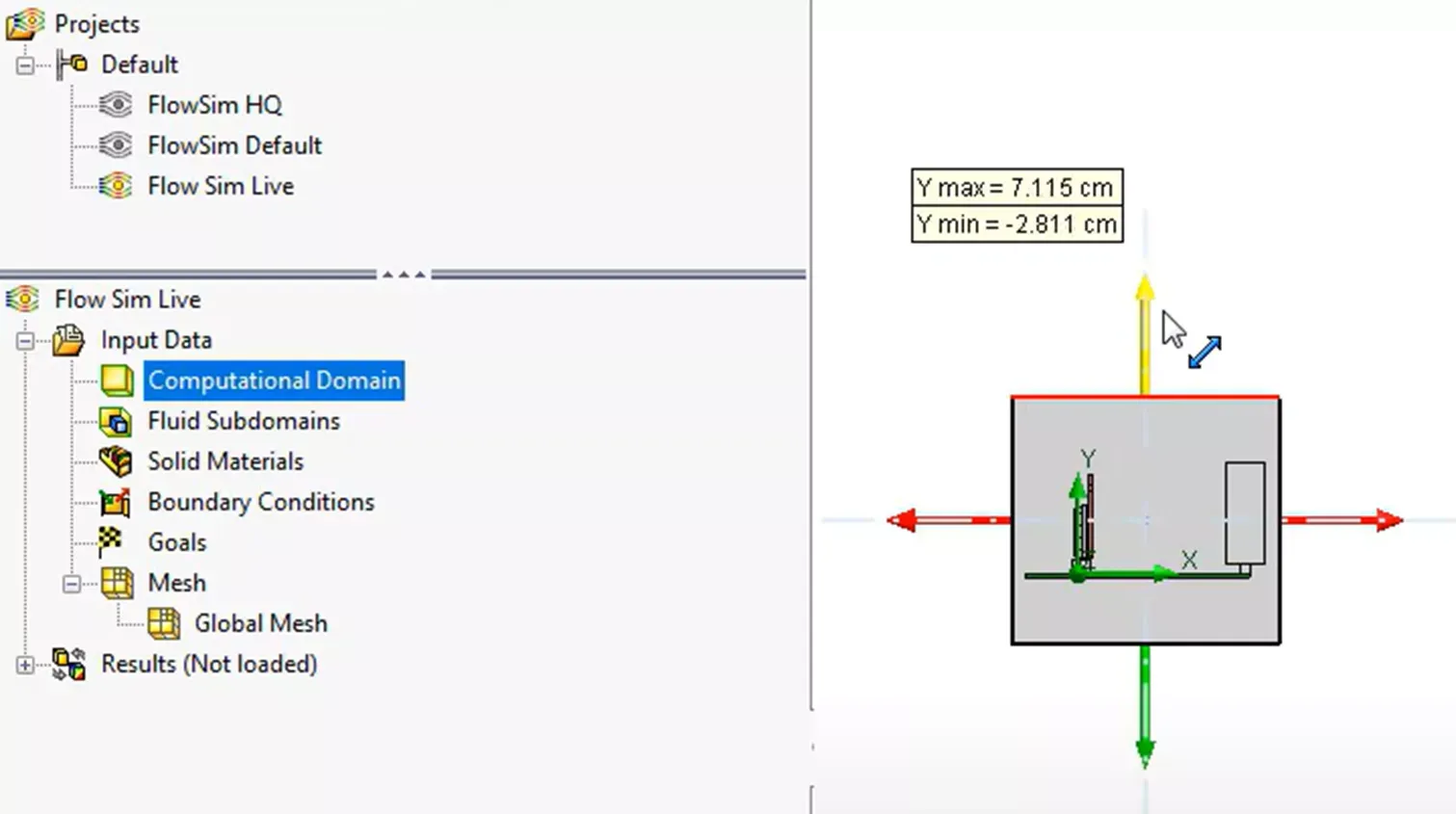
缩减计算域:计算域是流体仿真中模拟流体动力学和热分析的空间体积,本次仿真适当缩减计算域体积,以提高计算效率。

导入材料属性:直接从 CAD 模型中导入各零部件的材料属性,保证与前几次仿真的材料参数一致。

设置风扇特征:选取模型中风扇的工作面,设置风扇特征,无需建模风扇叶片及模拟叶片转动(该操作会大幅增加计算资源和时间),直接通过风扇特征理想化模拟特定风扇对空气介质的驱动效果。施加热生成率载荷:与前几次热分析一致,对微芯片施加3 瓦的体积热生成率载荷,作为热量来源。
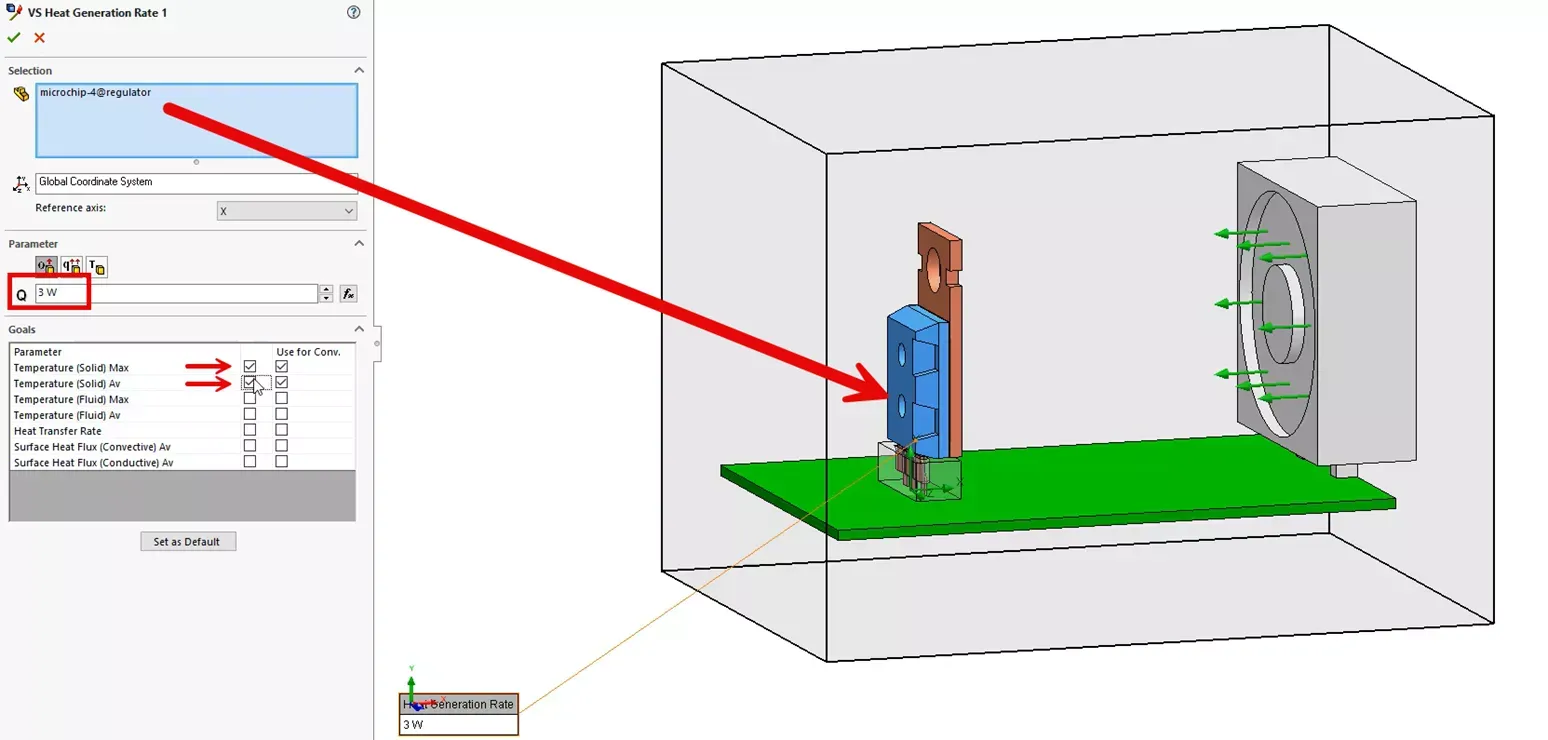
设置工程目标:

体积目标:添加芯片、散热器的最高温度和平均温度监测,实时追踪核心温度参数;

表面目标:添加散热器表面的对流换热系数监测,方便与前几次人工选取的系数进行对比。

设置接触热阻:与方法三一致,在芯片铜连接器与连接器引脚的接触区域设置接触热阻,阻值 0.01 (K・m²)/W,考虑接触面粗糙带来的热阻影响。
网格划分优化:
全局网格:将初始网格等级提升至 7 级,提高全局网格的细节度;

局部网格:对芯片、散热器、连接器等核心零部件进行局部网格细化,在固液交界面设置等距细化,保证核心区域的计算精度。

流体仿真的求解与监控
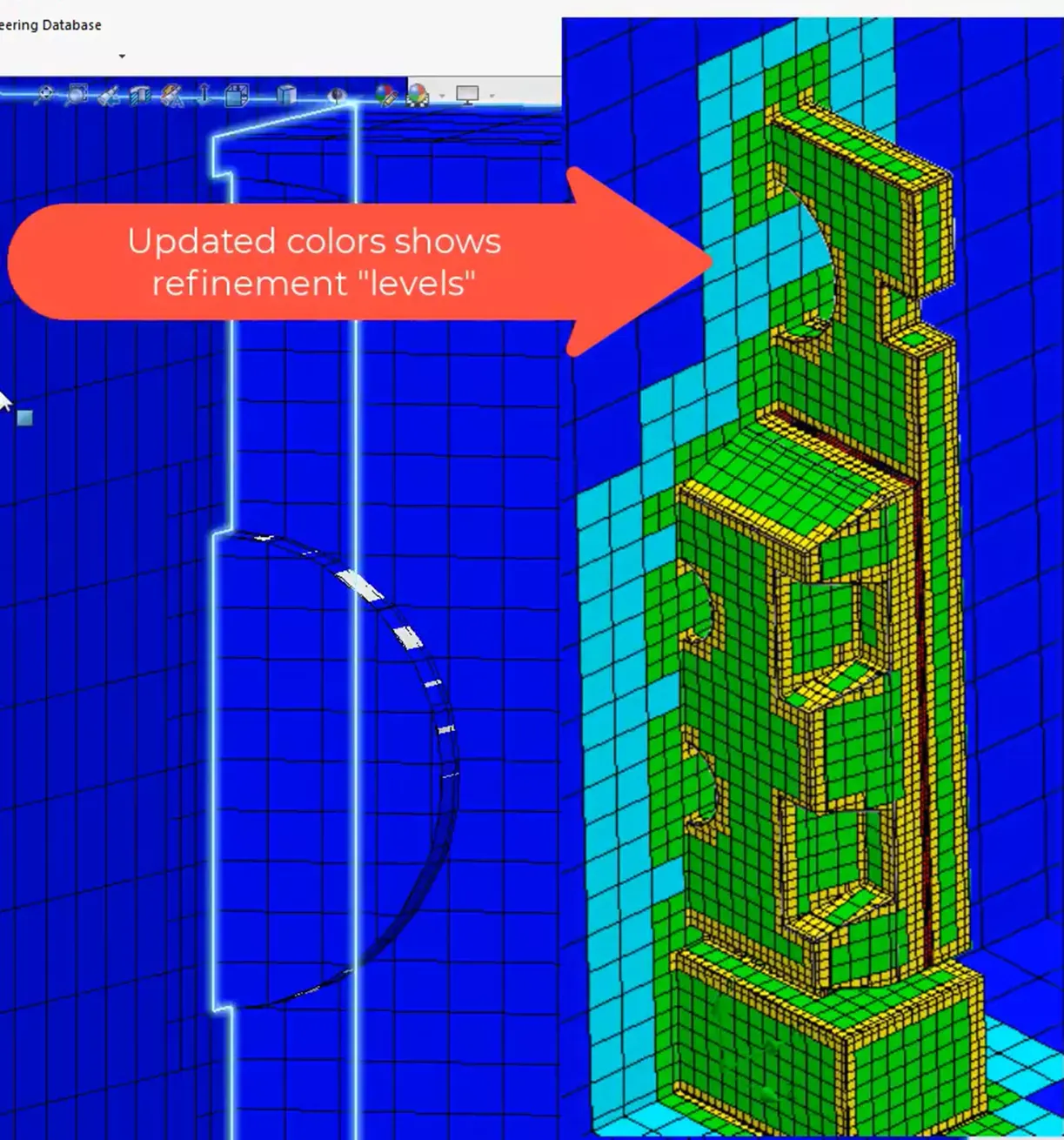
运行 SOLIDWORKS Flow Simulation 仿真,通过求解器窗口实时监控计算过程:计算流体动力学(CFD)仿真的耗时远长于常规有限元分析(FEA),求解器窗口可实时、定性 + 定量地展示结果参数的变化过程;若发现计算结果不符合预期,可提前终止计算并排查问题。
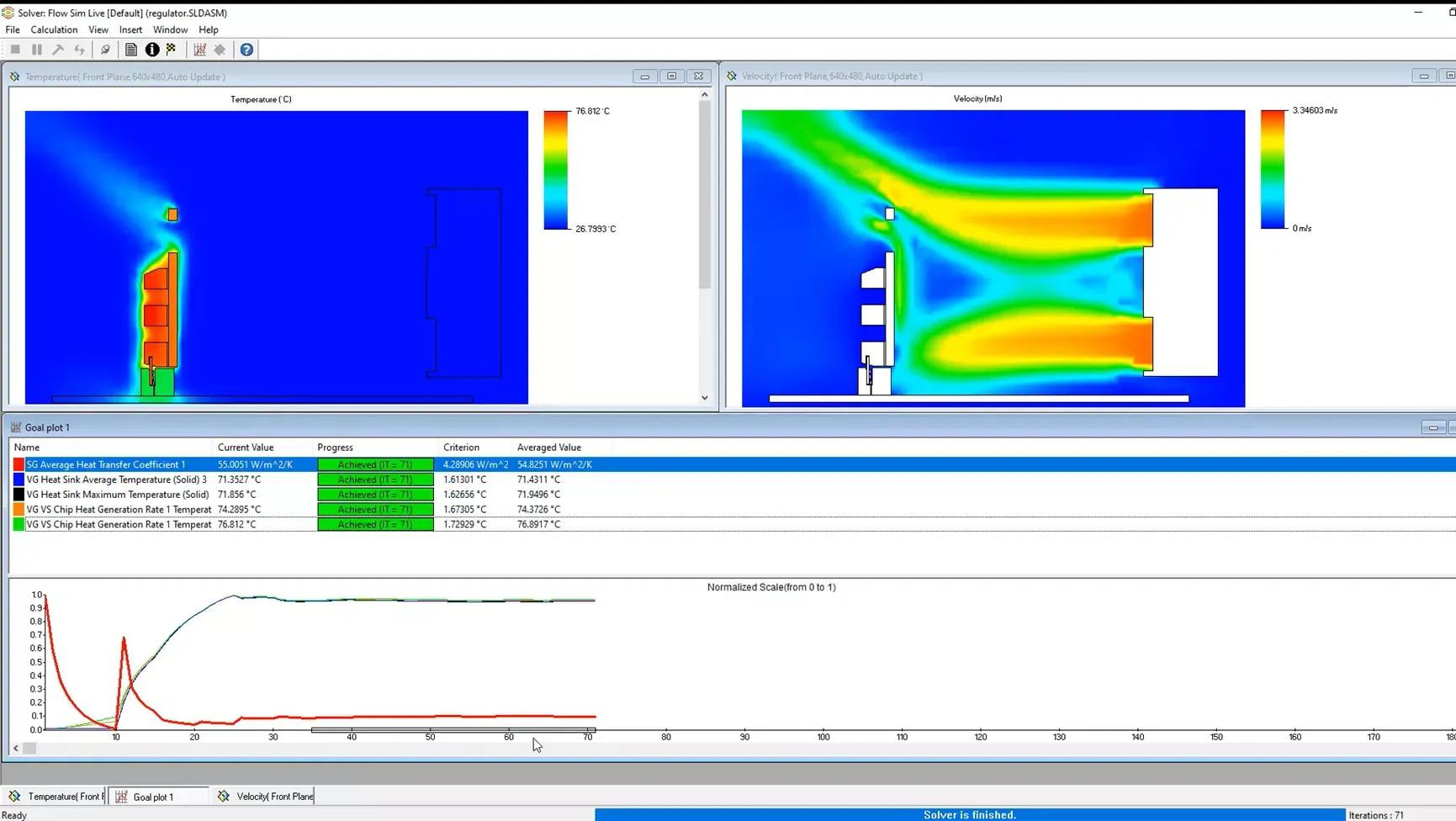
热分析结果
温度分布:仿真得到芯片的最高温度约为76~77℃,相比方法三 SOLIDWORKS Simulation 专业版的 82.3℃低数度,该结果因自动计算了所有对流换热系数,更贴合实际工况。

流场轨迹:通过流场轨迹云图可直接观察并动画演示空气介质的流动状态,清晰展示空气吹过芯片表面的速度分布(单位:m/s),动画功能可帮助工程师更直观地理解热系统的响应规律。
对流换热系数分布:生成对流换热系数表面云图,可观察到系数的非均匀分布规律;而方法三中的 SOLIDWORKS Simulation 专业版仅能对整个面人工指定统一的对流换热系数,本方法的结果更符合工程实际。

结构分析的设置与操作
新建静力学分析研究:采用与前几次完全相同的方式新建结构分析研究,也可直接复制已有研究,避免人为操作误差。
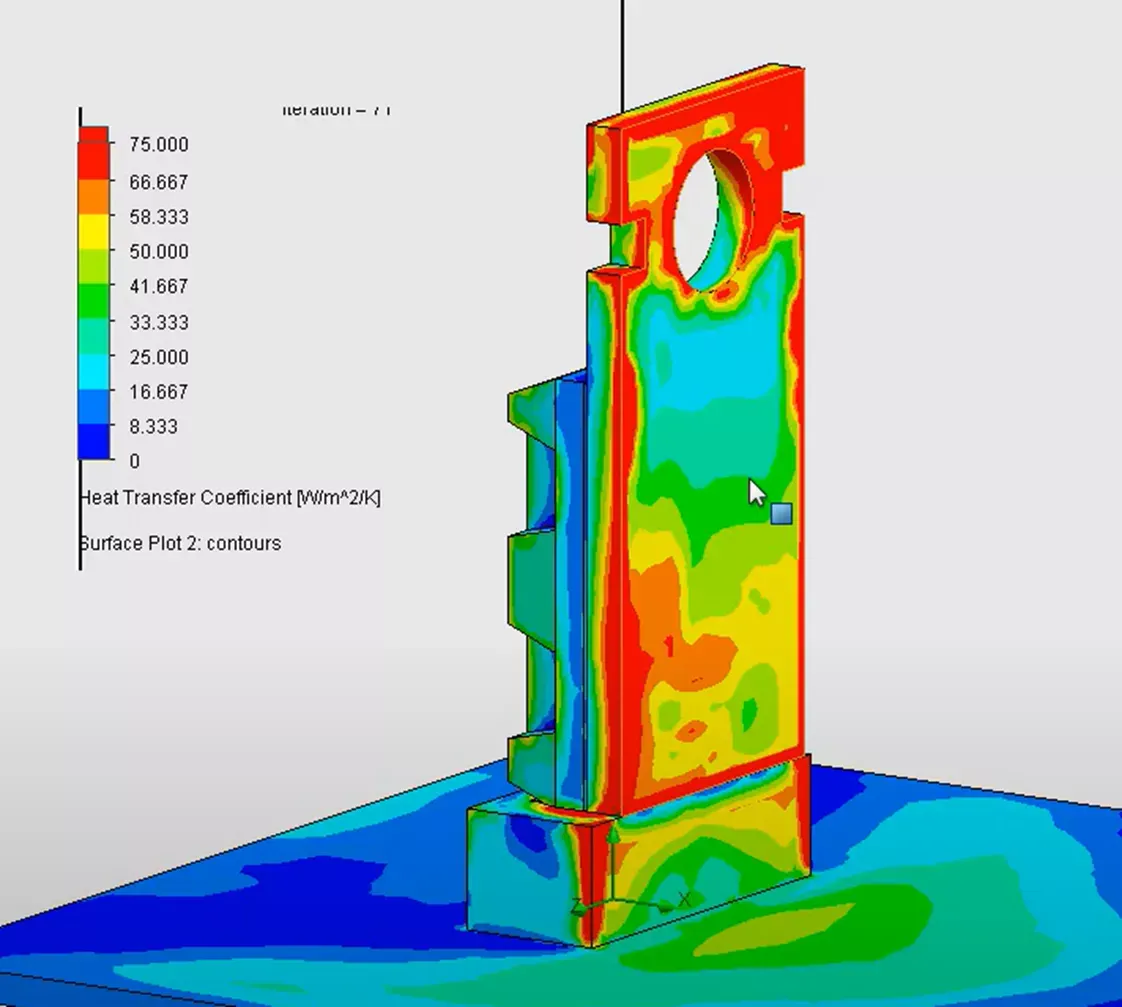
导入流体仿真热结果:在研究属性的 “流体 / 热效应” 选项卡中,勾选 “从 SOLIDWORKS Flow Simulation 导入温度”,选择上述流体仿真项目,设置温度导入的时间步为 71(0 秒),零应变参考温度仍为 300 开尔文。

仿真求解:完成设置后运行结构分析仿真,求解过程中可通过窗口查看求解进度、内存占用等信息。

结构分析结果
对芯片同一接触区域的应力进行测量,得到接触平均应力为81.39 MPa,该结果低于方法三的计算值。
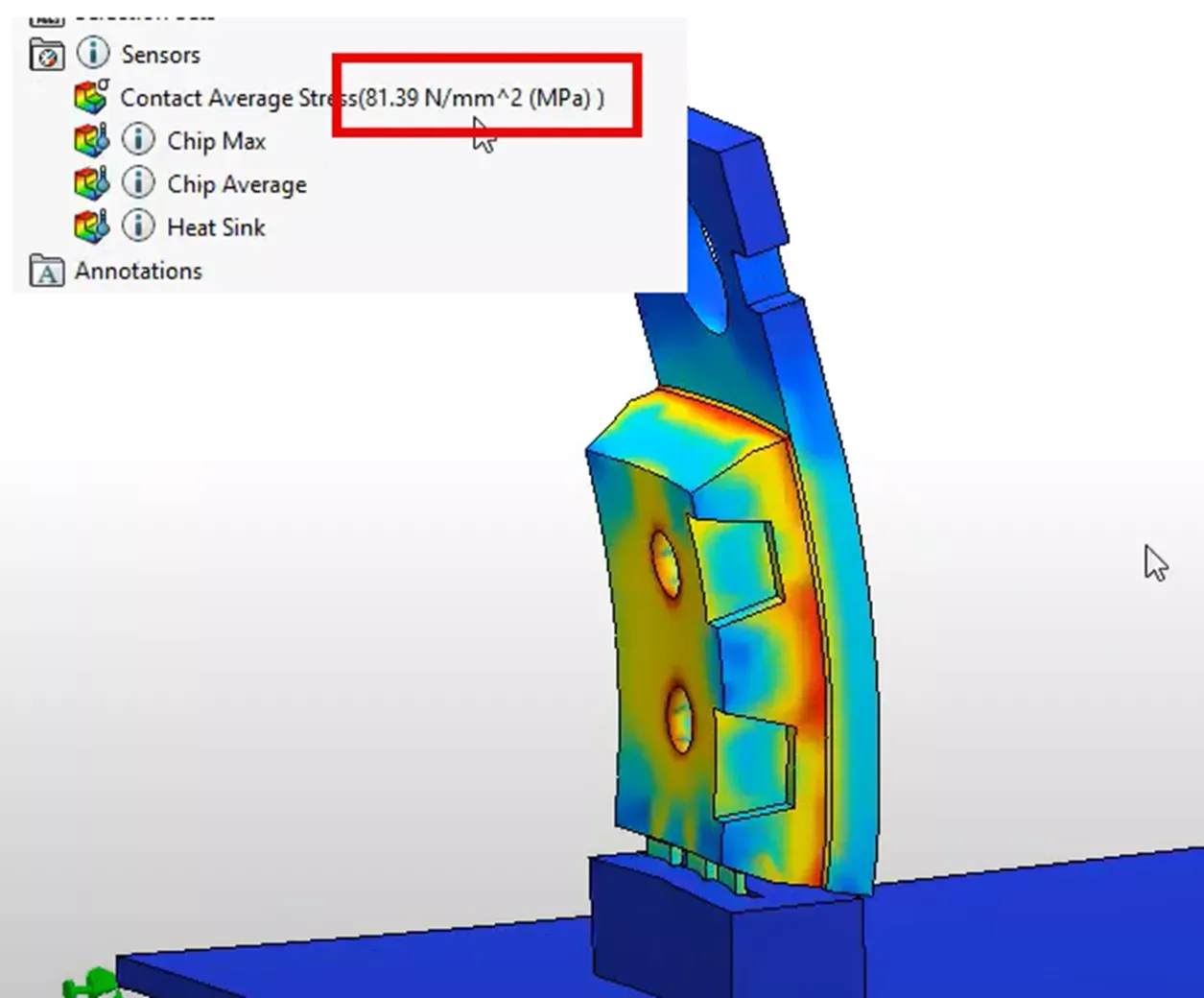
方法四的假设与结果总结
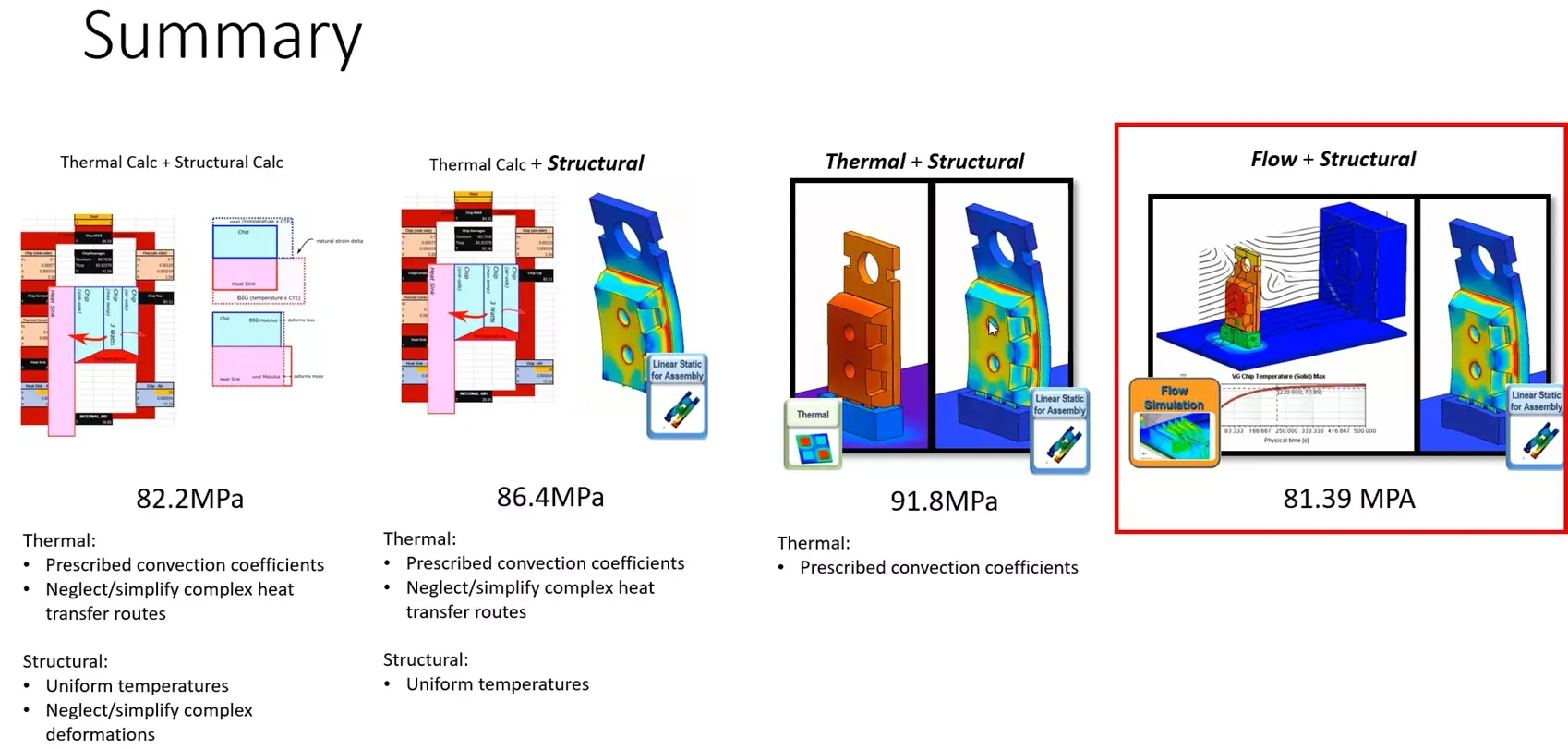
该结果是本次所有分析中假设条件最少的结果:热分析不再人工估算对流换热系数,且能模拟复杂的非均匀热载荷;结构分析则延续了方法三的高精度设置,因此该结果最贴合工程实际。
总结
本文采用多种方法对同一模型的热应力进行分析,结合了手工计算与多款 SOLIDWORKS 仿真工具,各方法的核心差异为:

方法一:热分析、结构分析均采用手工计算;
方法二:热分析手工计算,结构分析采用有限元分析(FEA);
方法三:热分析、结构分析均采用有限元分析(FEA);
方法四:热分析采用计算流体动力学(CFD),结构分析采用有限元分析(FEA)。
综上,SOLIDWORKS Simulation 仿真套件能够更精准地还原系统的实际几何形状,减少边界条件定义过程中的假设条件,从而在评估产品设计是否满足性能指标时,提供更可靠的分析结果。
更多SOLIDWORKS相关教程,培训支持,正版授权,请关注智诚科技ICT,电话:400-886-6353
获取正版软件免费试用资格,有任何疑问拨咨询热线:400-886-6353或 联系在线客服
未解决你的问题?请到「问答社区」反馈你遇到的问题,专业工程师为您解答!














